Introduction: Importance industrielle et défis techniques de via le remplissage
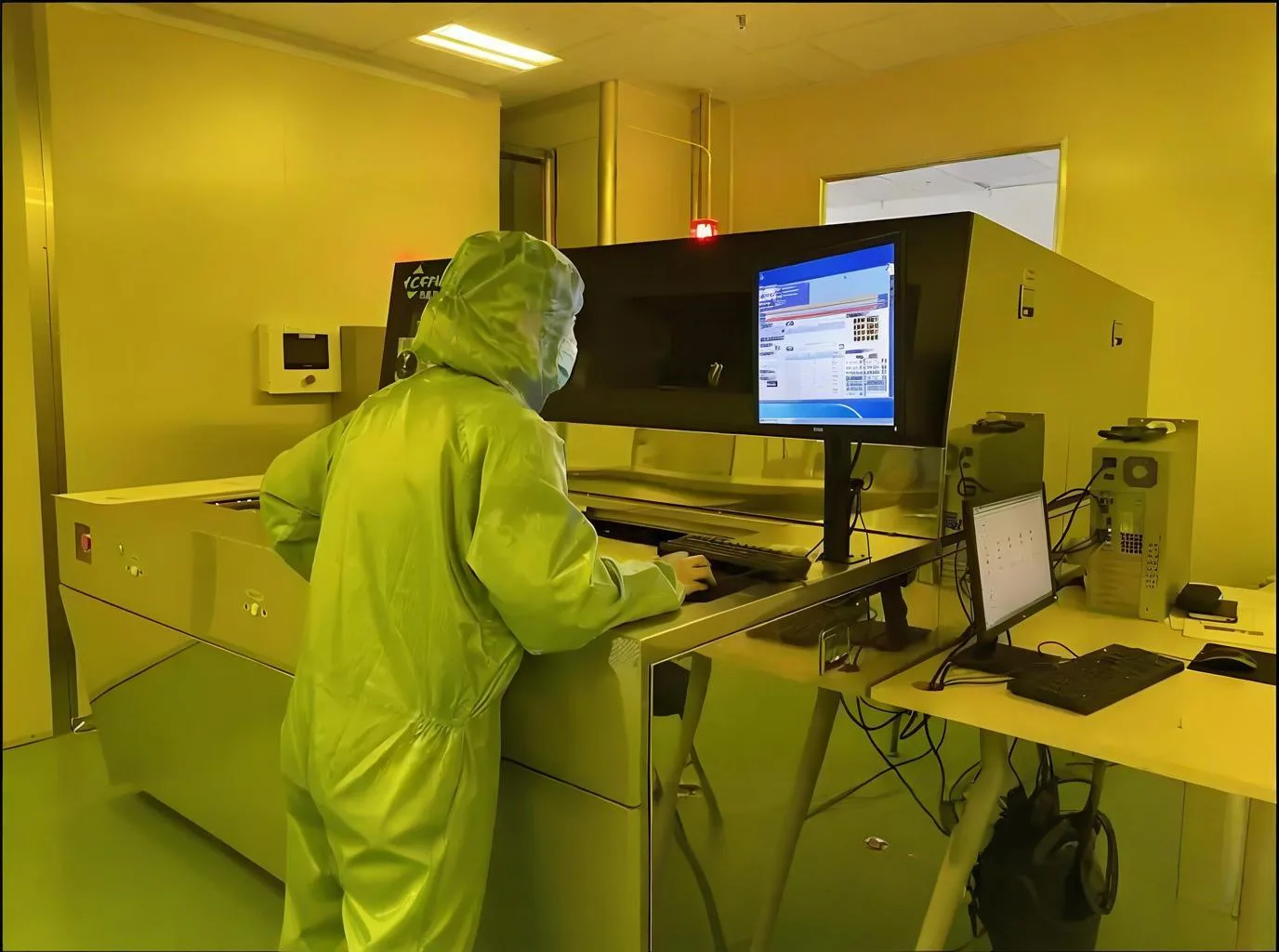
Dans 2023, le global PCB Marché dépassé $89.3 milliard (Prismark), avec via le remplissage des technologies influençant de manière critique 30% fluctuations de rendement dans les dispositifs de communication 5G. Cet article analyse les équations thermodynamiques et les matrices de processus pour révéler comment via le remplissage impacte l'intégrité du signal et la fiabilité thermique.
1. Via le cadre de la technologie de remplissage
1.1 Physique microvia et fenêtre de processus
Par IPC-6012E, Les vias sont définis comme des trous conducteurs ≤0,70 mm (28mil). La fenêtre du processus de remplissage suit:
D = (K × T)/(σ × η)
Où:
- D: Diamètre maximal à remplir (mm)
- T: Substrat tg (° C)
- un: Tension de surface en résine (MN / M)
- ou: Viscosité de remplissage (PA · S)
- K: Coefficient de traitement (0.02–0.05)
Pour les substrats FR-4 (Tg = 140 ° C), remplir les trous >0.40MM nécessite matériels avec σ<25mn / m et η<120PA · S.
2. Physique de remplissage de résine
2.1 Enterré via le seuil de profondeur
Le remplissage de la résine devient obligatoire pour les VIA enfouies ≥ 0,8 mm en raison de la dynamique du flux de plastification:
P = (γ × cosθ)/(R × H)
Où:
- P.: Pression de remplissage (MPA)
- c: Tension de surface préimpressive
- ème: Angle de contact
- r: Via le rayon
- H: Via la profondeur
À h≥ 0,8 mm, pression de plastification standard (3–5MPA) ne parvient pas à remplir les vides, nécessitant le remplissage de résine assistée par l'assistance.
2.2 Résine vs. Garniture de laminage: 6-Comparaison dimensionnelle
| Paramètre | Remplissage de résine | Garniture de laminage |
|---|---|---|
| Uniformité d'épaisseur | ± 5% | ± 15% |
| Risque de délaminage | <0.1% | 0.5–1,2% |
| Coût | $0.35/dm² | $0.12/dm² |
| Largeur de trace minimale | 50µm | 75µm |
| Cycles thermiques | 3,000 | 1,500 |
| Perte de signalisation (@ 10 GHz) | 0.15db / pouce | 0.25db / pouce |
3. Processus de remplissage du masque de soudure
3.1 Modèle de flux d'encre en imagerie négative
Le remplissage du masque de soudure suit une équation de Hagen-Poiseuille modifiée:
Q = (πr⁴Δp)/(8μl) × (1 – e^(-T / t))
Avec le temps constant t = mr² /(4c), expliquant 50% Taux de remplissage dans les vias semi-remplies lorsque le temps d'exposition T≈τ.
3.2 Étude de cas de défaillance du conseil d'administration
Les vias non remplis dans les PCB de la station de base 5G ont provoqué des perles d'étain, modélisé par l'équation d'Arrhenius:
t_f = a × exp(EA /(kt))
Les tests ont montré que le MTBF est tombé de 10 à 2.3 années à 85 ° C / 85% Rh. Implémentation de vias de 0,30 mm avec ouvertures de masques de soudure ≤(par diamètre + 0,08 mm) réduction des défauts de billes d'étain de 12% à 0.7%.
4. Avancé via les technologies de remplissage
4.1 Remplissage conducteur pour le blindage EMI
Le remplissage de l'époxy argenté améliore l'efficacité du blindage (Avec):
SE = 20log(1/(1-r)) + 10enregistrer(N)
À 80% taux de remplissage (P = 0,8), Se s'améliore par 18 dB à 1 GHz.
4.2 Remplissage de cuivre plaqué pour l'intégrité du signal
Rempli de cuivre via l'impédance:
Z0 = (87/√ε_r)LN(5.98h /(0.8W + T))
Les piliers en cuivre réduisent la variation d'impédance de ± 15% à ± 5%, Abaissement du BER de 10⁻⁶ à 10⁻¹² à 28 Gops.
5. Cadre de décision de processus
Coût total de possession (TCO) Analyse
- Electronique grand public: Le remplissage du masque de soudure offre le plus bas TCO à 5 ans
- Automobile: Résine + Le remplissage partiel de cuivre assure la fiabilité
- Militaire: Les piliers en cuivre optimisent l'intégrité du signal
Conclusion
Via le remplissage pour les applications 6G
Comme les fréquences térahertz exigent moins de 50 μm par précision, Le frittage de nano-silver apparaît comme une percée. La maîtrise via le remplissage de la physique conduira la nouvelle génération circuit imprimé haute fréquence innovation.