導入: 充填経由の産業的重要性と技術的課題
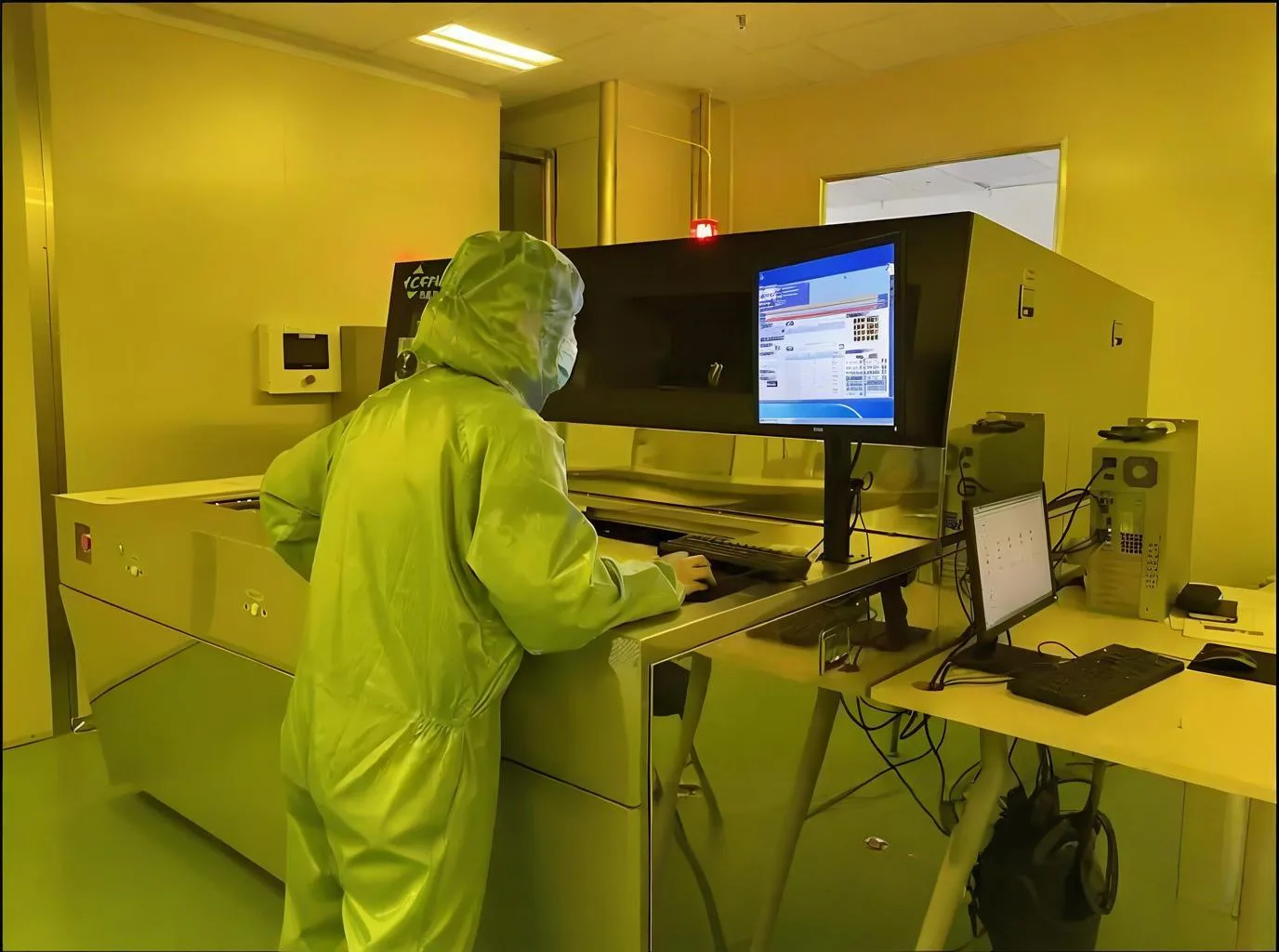
で 2023, グローバル プリント基板 市場を上回りました $89.3 十億 (プリスマーク), 充填テクノロジーを介して、非常に影響を与えています 30% 5G通信デバイスの変動をもたらします. この記事では、熱力学方程式とプロセスマトリックスを分析して、充填経由の影響が信号の整合性と熱の信頼性にどのように影響するかを明らかにします.
1. テクノロジーフレームワークの充填を介して
1.1 Microviaの物理学とプロセスウィンドウ
IPC-6012Eごと, VIAは、導電性穴≤0.70mmとして定義されます (28ミル). 充填プロセスウィンドウが続きます:
d = (k×t)/(σ×η)
どこ:
- D: 最大充填可能な直径 (mm)
- T: 基板TG (℃)
- a: 樹脂の表面張力 (mn/m)
- または: フィラー粘度 (PA・s)
- K: プロセス係数 (0.02–0.05)
FR-4基質用 (TG = 140°C), 穴を埋める >0.40MMが必要です 材料 σで<25Mn/Mおよびη<120PA・s.
2. 樹脂物理学
2.1 深さのしきい値を介して埋葬されます
樹脂の充填は、ラミネートフローダイナミクスのために0.8mm以上の埋設バイアスの場合は必須になります:
p = (γ×cosθ)/(r×h)
どこ:
- p: 充填圧力 (MPa)
- c: プリプレグ表面張力
- th: 接触角
- r: 半径を介して
- h: 深さを介して
H≥0.8mmで, 標準的な積層圧力 (3–5MPA) 空白を埋めることができません, 真空支援樹脂充填を必要とする.
2.2 樹脂対. ラミネーションフィリング: 6-寸法比較
| パラメーター | 樹脂充填 | ラミネーションフィリング |
|---|---|---|
| 厚さの均一性 | ±5% | ±15% |
| 剥離リスク | <0.1% | 0.5–1.2% |
| 料金 | $0.35/dm² | $0.12/dm² |
| 最小トレース幅 | 50μm | 75μm |
| サーマルサイクル | 3,000 | 1,500 |
| 信号損失 (@10GHz) | 0.15db/inch | 0.25db/inch |
3. はんだマスク充填プロセス
3.1 ネガティブイメージングのインクフローモデル
はんだマスクの充填は、修正されたハーゲンポイゼーユ方程式に従います:
Q = (πr⁴δp)/(8μL) × (1 – e^(-T/T))
時定数で t =mr²/(4c), 説明 50% 暴露時間t≈τの場合、半充填VIAのレートを埋めます.
3.2 HASLボード障害のケーススタディ
5GベースステーションのPCBSの未充填バイア, Arrhenius方程式によってモデル化されています:
T_F = A×Exp(EA/(KT))
テストでは、MTBFが落ちたことが示されました 10 に 2.3 85°C/85%RHでの年. はんだマスク開口部を使用して0.30mm VIAを実装します≤(直径 +0.08mm経由) からのスズビーズの欠陥の減少 12% に 0.7%.
4. 充填技術を介して高度
4.1 EMIシールドのための導電性充填
銀エポキシ充填は、シールドの有効性を高めます (と):
se = 20log(1/(1-r)) + 10ログ(N)
で 80% 充填率 (p = 0.8), SEは1GHzで18dB増加します.
4.2 信号の完全性のためのメッキ銅の充填
インピーダンスを介して銅で充填された:
Z0 = (87/√ε_r)ln(5.98H/(0.8w+t))
銅の柱は、インピーダンスの変動を±15%から±5%に減らします, 28gbpsでBERを10°から10 µ²に下げます.
5. プロセス決定フレームワーク
総所有コスト (TCO) 分析
- 家電: はんだマスク充填は、最低5年のTCOを提供します
- 自動車: 樹脂 + 部分銅の充填により、信頼性が保証されます
- 軍隊: 銅の柱は、信号の完全性を最適化します
結論
6Gアプリケーションの充填を介して
Terahertzの周波数は、精度でサブ50μmを要求するため, ナノシルバーの焼結はブレークスルーとして現れます. 物理学を充填してマスターすると、次世代が促進されます 高周波プリント基板 革新.