고성능 BGA IC 기판: 고급 IC 패키징을 위한 정밀 기반
작아지는 시대에, 더 빠르게, 그리고 더욱 강력한 전자제품, 고급 IC 패키징이 중요합니다. 실리콘 다이와 메인 사이의 필수 인터페이스 역할 인쇄 회로 기판 (PCB), 그만큼 BGA IC 기판 하이엔드 반도체 패키지의 핵심 부품입니다.. UGPCB는 심층적으로 활용합니다. PCB 제조 고성능을 제공하기 위한 전문성과 고급 프로세스, 믿을 수 있는 BGA 패키지 기판 솔루션.
1. BGA IC 기판이란 무엇입니까??
BGA IC 기판은 특수한 유형의 고밀도 상호 연결 (HDI) PCB Ball Grid Array를 위해 명시적으로 설계됨 (BGA) 포장. 그것은 표준이 아니다 회로 기판 하지만 정밀 다층 상호 연결 구조. 한쪽은 초미세 회로를 통해 다이와 인터페이스합니다., 반대쪽은 연결되어 있지만 기본 PCB 보드 일련의 솔더볼을 통해, 네 가지 주요 기능을 수행: 전기적 상호 연결, 신호 전송, 열 방출, 그리고 물리적인 지원.
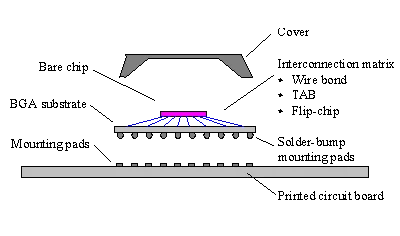
2. 디자인 필수사항 & 작동원리
디자인 필수사항:
-
초고배선 밀도: 증가하는 I/O 수를 수용하기 위해, 기판이 필요합니다 초미세 라인 디자인. UGPCB는 안정적으로 달성합니다. 30μm/30μm 최소 선폭/공간, 핀 수가 많은 칩을 위한 효율적인 팬아웃 라우팅 가능.
-
정확한 등록 & 치수 안정성: 다이와 솔더 볼 간의 정렬은 매우 정확해야 합니다.. 우리의 핵심 소재, Mitsubishi 가스 HF BT HL832NX-A-HS, 낮은 CTE를 제공합니다 (열 팽창 계수) 우수한 치수 안정성, 열응력으로 인한 변형 및 정렬 불량 방지.
-
안정적인 마이크로비아: 레이어 간 상호 연결은 레이저 드릴링된 블라인드 비아에 따라 달라집니다.. 우리의 0.075mm 레이저 드릴링 고밀도 수직 연결을 용이하게 하는 기능 (예를 들어, 1-2, 3-4 레이어), 신호 무결성 보장.
-
최적화된 신호 & 전력 무결성: 신중하게 설계된 스택업 (예를 들어, 1L-4L, 1L-2L, 3귀하의 사양에 따라 L-4L) 평면 할당은 고속 신호를 위한 저손실 경로를 제공하고 깨끗한 신호를 전달합니다., 칩에 안정적인 전력 공급.
작동원리:
다이는 기판의 상단 표면에 부착됩니다. (일반적으로 레이어 1) 와이어 본딩 또는 플립칩 기술을 통해. 칩의 전기 신호가 라우팅됩니다., 재분배 (RDL), 기판 내부를 통해 전달됩니다. 아주 미세한 흔적 그리고 마이크로 비아 (레이저/기계적 구멍). 최종적으로 바닥 표면의 솔더 볼 어레이를 통해 빠져나와 더 큰 커넥터에 연결됩니다. PCB (PCB 조립). 본질적으로 소형화되어 있습니다., 칩별, 고급 인쇄 회로 기판.
3. 핵심 자료, 구조 & 주요 특징
-
핵심 자료: Mitsubishi 가스 HF BT HL832NX-A-HS 고성능 라미네이트. 그로 유명한 낮은 유전 상수 (DK), 낮은 소산 인자 (Df), 높은 내열성 (높은 Tg), 탁월한 치수 안정성, 고속을 위한 이상적인 선택입니다, 고주파 IC 패키징 기판.
-
주요 구조: 4-레이어 빌드 디자인을 통해 쌓인 (1-2, 3-4 레이어 블라인드 비아) 더 높은 라우팅 밀도를 위해. 전반적인 PCB 두께는 0.3mm입니다., 얇은 프로파일 패키징 요구 사항 충족.
-
표면 마감:****에네픽 (전기 니켈 전기 팔라듐 침지 금, 2μ”). 이 마감재는 니켈의 차단 특성을 결합합니다., 팔라듐의 내식성, 그리고 금의 뛰어난 납땜성. 을 위한 선호되는 선택입니다 미세 피치 BGA 솔더 볼 부착, 장기 신뢰성 보장.
-
솔더 마스크 & 열기: 우리는 Taiyo PSR4000 AUS308 고성능 액체 광이미지 솔더 마스크 (LPSM), 높은 해상도와 신뢰성으로 유명한, 개구부를 완벽하게 정의 0.1mm 기계식 관통 구멍 그리고 패드.
4. 분류 & 기본 응용 프로그램
-
분류: 주로 상호연결 방식에 따라 분류됩니다.: 와이어 본딩 기판 그리고 플립 칩 기판. 제공되는 사양 (초 화성 라인, 에네픽) 특히 적합합니다 플립칩 및 기타 고급 패키징 응용 분야.
-
기본 응용 프로그램:
-
중앙 처리 장치 (CPU/GPU) 포장
-
모바일 장치 애플리케이션 프로세서 (ap) & 베이스밴드 칩
-
고속 네트워킹 & 통신 칩 (예를 들어, FPGA, ASIC)
-
인공 지능 (일체 포함) & 기계 학습 가속기
-
고급 메모리 패키징 (예를 들어, HBM)
-
이러한 애플리케이션은 고밀도, 고성능 PCBA 설계.
-
5. UGPCB의 BGA IC 기판 생산 공정 & 품질 관리
우리의 BGA 회로 기판 제조 엄격한 기준을 따른다, 높은 수준의 흐름:
내층 이미징 → 레이저 드릴링 / 기계 드릴링 → 홀 금속화 (구리 도금) → Outer Layer Imaging → Solder Mask 적용 (PSR4000) → ENEPIG 표면 마감 → 전기 테스트 → 최종 검사.
전체 프로세스는 통제된 클린룸 환경에서 발생합니다. (클래스 10K/1K), 자동 광학 검사 활용 (AOI), 레이저 측정 시스템, 그리고 더, 모든 것을 보장 BGA 패키징 PCB 칩 수준 신뢰성 표준 충족.
6. BGA IC 기판으로 UGPCB를 선택하는 이유?
-
프리미엄 소재 보증: Mitsubishi Gas와 같은 최상위 공급업체의 코어 라미네이트는 처음부터 성능을 보장합니다..
-
고급 공정 능력: 30/30μm 라인/공간 및 0.075mm 레이저 마이크로비아 최첨단 칩 패키징 디자인 지원.
-
초박형 핵심 전문성: 고수익 분야에서 검증된 경험, 대량 생산 0.3mm 및 더 얇은 보드.
-
포괄적인 표면 마감 옵션: 우리는 다양한 본딩/솔더링 요구 사항을 충족하기 위해 ENEPIG를 포함한 다양한 고급 마감재를 제공합니다..
-
원스톱 서비스: 에서 PCB 설계 검토 그리고 빠르게 회전하는 프로토타입 대량 생산에, 우리는 엔드 투 엔드를 제공합니다 PCBA 기판 솔루션 새로운 칩 프로젝트를 위해.
결론:
무어의 법칙의 물리적 한계에 접근함에 따라, 첨단 패키징은 지속적인 전자 제품 성능 성장의 핵심입니다. 믿을 수 있는 것을 선택하는 것 BGA IC 기판 칩의 성공을 위한 탄탄한 기반을 마련합니다. 칩 설계에 참여하고 있는지 여부, 포장, 테스트, 또는 PCBA 제조, UGPCB는 귀하의 신뢰할 수 있는 파트너입니다..
오늘 저희에게 연락하세요 당신의 논의를 위해 BGA 패키지 기판, HDI PCB 요구 사항, 그리고 견적을 요청해보세요. 차세대 전자 혁신을 가능하게 하기 위해 협력합시다!