Introducere: Semnificație industrială și provocări tehnice ale completării prin completare
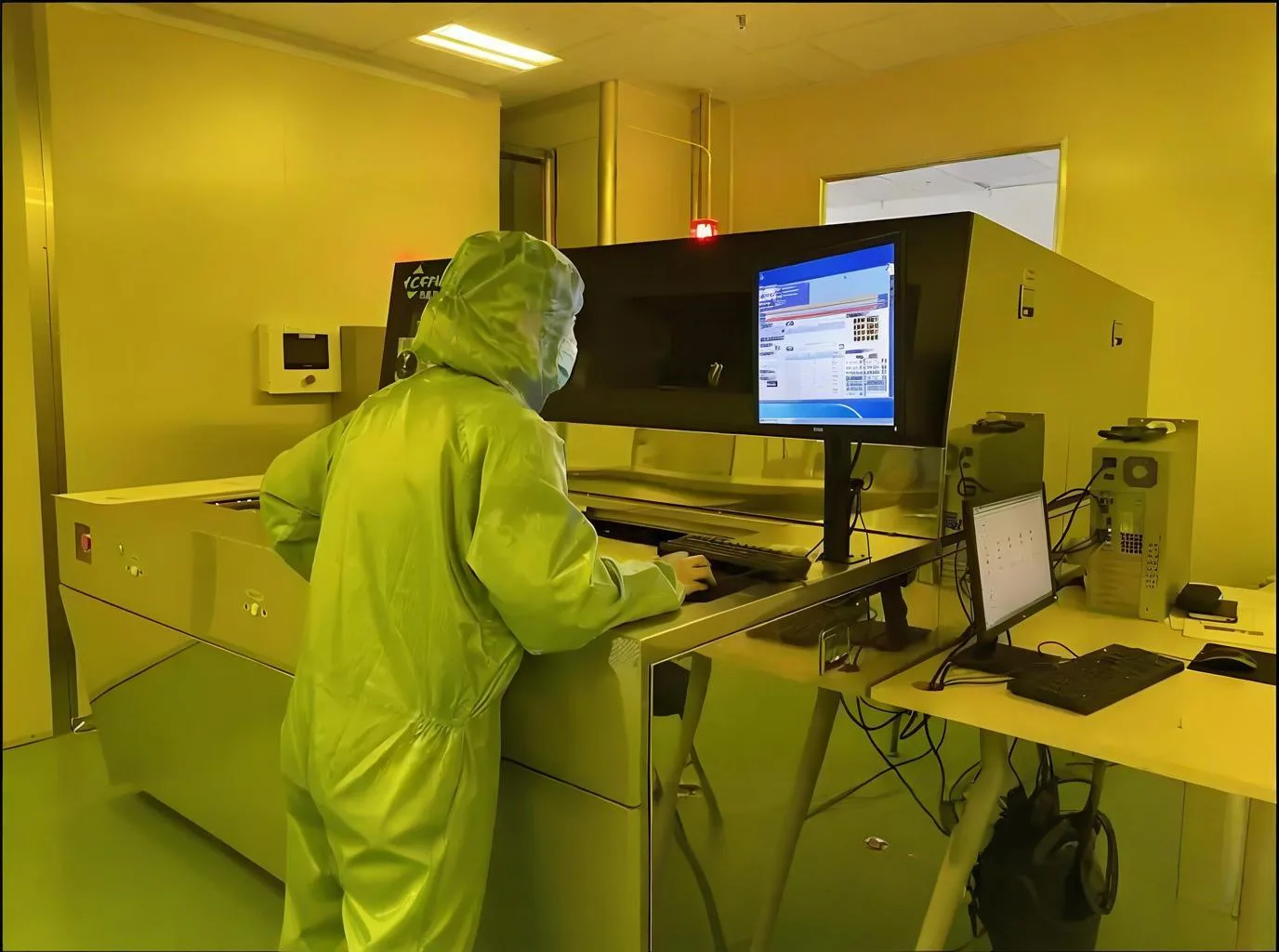
În 2023, Global PCB piața depășită $89.3 miliard (Prismark), prin intermediul tehnologiei de umplere care influențează critic 30% Fluctuații de randament în dispozitivele de comunicare 5G. Acest articol analizează ecuațiile termodinamice și matricile de proces pentru a dezvălui modul în care prin umplerea impactului integrității semnalului și a fiabilității termice.
1. Prin intermediul cadrului tehnologiei de umplere
1.1 Fereastra de fizică și proces microvia
Pe IPC-6012E, VIA -urile sunt definite ca găuri conductive ≤0,70mm (28mil). Urmează fereastra procesului de umplere:
D = (K × T.)/(σ × η)
Unde:
- D.: Diametru maxim de umplere (mm)
- T: Substrat TG (° C.)
- o: Tensiunea de suprafață din rășină (MN/m)
- sau: Vâscozitate de umplutură (Pa · s)
- K: Coeficient de proces (0.02–0.05)
Pentru substraturile FR-4 (TG = 140 ° C), Găuri de umplere >0.40MM necesită materiale cu σ<25Mn/M și η<120Pa · s.
2. Fizica de umplere a rășinii
2.1 Îngropat prin pragul de adâncime
Umplerea de rășină devine obligatorie pentru VIA -urile îngropate ≥0,8 mm din cauza dinamicii fluxului de laminare:
P = (γ × cosθ)/(r × h)
Unde:
- P: Presiune de umplere (MPA)
- C.: Pregreg tensiunea de suprafață
- Th: Unghiul de contact
- r: Prin rază
- h: Prin adâncime
La H≥0.8mm, Presiune standard de laminare (3–5mpa) nu reușește să umple goluri, necesitând umplutura de rășină asistată de vid.
2.2 Rășină vs. Umplutură de laminare: 6-Comparație dimensională
| Parametru | Umplutură de rășină | Umplutură de laminare |
|---|---|---|
| Uniformitatea grosimii | ± 5% | ± 15% |
| Risc de delaminare | <0.1% | 0.5–1,2% |
| Cost | $0.35/DM² | $0.12/DM² |
| Lățimea minimă a urmelor | 50μm | 75μm |
| Cicluri termice | 3,000 | 1,500 |
| Pierderea semnalului (@10GHz) | 0.15db/inch | 0.25db/inch |
3. Proces de umplere a măștii de lipit
3.1 Model de flux de cerneală în imagini negative
Umplerea de mască de lipit urmează o ecuație modificată de Hagen-Poiseuille:
Q = (πr⁴Δp)/(8µl) × (1 – e^(-T/T.))
Cu constantă de timp t = mr²/(4C.), explicând 50% Completați tarifele în VIA-uri semi-umplute atunci când timpul de expunere t≈τ.
3.2 Studiul de caz al eșecului consiliului de administrație
VIA -uri neumplute în stația de bază 5G PCB -urile au provocat margele de staniu, modelat de ecuația Arrhenius:
t_f = a × exp(Ea/(kt))
Testarea a arătat că MTBF a scăzut de la 10 la 2.3 ani la 85 ° C/85%RH. Implementarea VIA -urilor de 0,30 mm cu deschideri de mască de lipit ≤(prin diametru +0,08mm) defecte reduse de margele de staniu din 12% la 0.7%.
4. Avansat prin intermediul tehnologiilor de umplere
4.1 Umplutură conductoare pentru ecranarea EMI
Umplerea epoxidică de argint îmbunătățește eficacitatea de protecție (Cu):
SE = 20log(1/(1-r)) + 10jurnal(N)
La 80% rata de umplere (P = 0,8), SE se îmbunătățește cu 18db la 1GHz.
4.2 Umplerea de cupru placată pentru integritatea semnalului
Plăcut de cupru prin impedanță:
Z0 = (87/√ε_R)ln(5.98h/(0.8W+T.))
Stâlpii de cupru reduc variația impedanței de la ± 15% la ± 5%, coborârea BER de la 10⁻⁶ la 10⁻¹² la 28 Gbps.
5. Cadrul decizional de proces
Costul total al proprietății (TCO) Analiză
- Electronica de consum: Umplerea de mască de lipit oferă cel mai mic TCO de 5 ani
- Auto: Răşină + Umplerea parțială de cupru asigură fiabilitatea
- Militar: Stâlpii de cupru optimizează integritatea semnalului
Concluzie
Prin completare pentru aplicații 6G
Deoarece frecvențele terahertz solicită sub-50 μm prin precizie, Sinteringul nano-argint apare ca o descoperire. Stăpânirea prin fizică de umplere va conduce la următorul gen PCB de înaltă frecvență inovaţie.