Введение: Промышленное значение и технические проблемы VIA заполнения
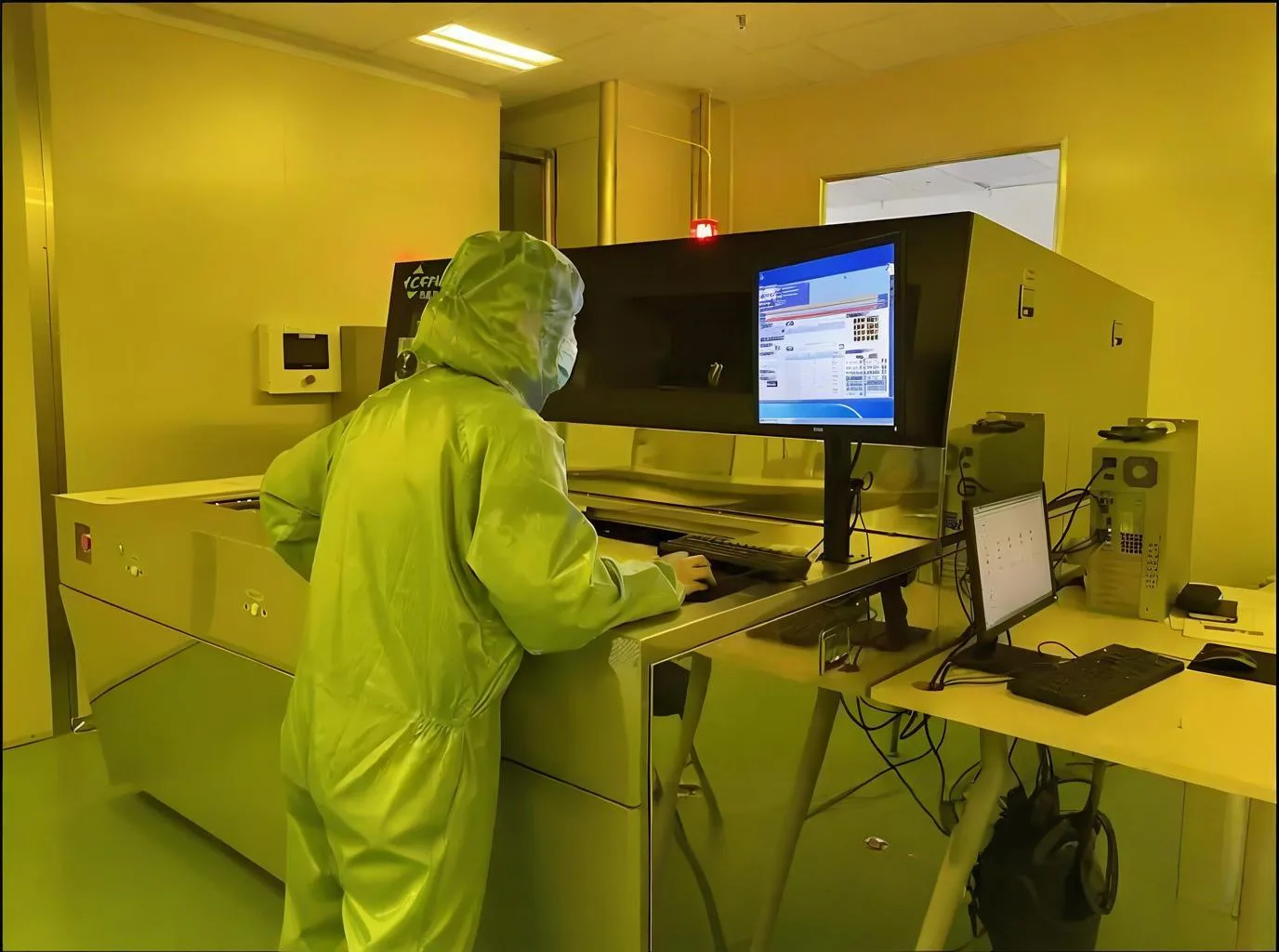
В 2023, Глобальный печатная плата Рынок превзошел $89.3 миллиард (Присмарк), с технологией наполнения, критически влияя на 30% Допустимые колебания в устройствах связи 5G. В этой статье анализируются термодинамические уравнения и матрицы процессов, чтобы показать, как заполнение влияет на целостность сигнала и тепловую надежность.
1. Через технологическую структуру заполнения
1.1 Микровия Физика и окно процесса
За IPC-6012E, VIA определяются как проводящие отверстия ≤0,70 мм (28мил). Окно процесса заполнения следует:
D = (K × T.)/(σ × η)
Где:
- Дюймовый: Максимальный заполненный диаметр (мм)
- Т: Субстрат Tg (°С)
- а: Поверхностное натяжение смолы (мн/м)
- или: Заполнитель вязкость (Па · с)
- К: Коэффициент процесса (0.02–0.05)
Для субстратов FR-4 (Tg = 140 ° C), заполнение отверстий >0.40MM требует материалы с σ<25Mn/M и η<120Па · с.
2. Физика заполнения смолы
2.1 Похоронен по порогу глубины
Наполнение смолы становится обязательным для захороненных VIAS ≥0,8 мм из -за динамики ламинирования потока:
P = (γ × cosθ)/(r × h)
Где:
- П: Давление заполнения (МПА)
- в: Поверхностное натяжение
- тур: Угол контакта
- ведущий: Через радиус
- час: Через глубину
При H≥0,8 мм, Стандартное давление ламинирования (3–5mpa) не заполняет пустоты, Требует начинки из смолы с помощью вакуума.
2.2 Смола против. Ламинирование: 6-Размерное сравнение
| Параметр | Смола начинка | Ламинирование |
|---|---|---|
| Толщина однородность | ± 5% | ± 15% |
| Риск расслоения | <0.1% | 0.5–1,2% |
| Расходы | $0.35/дм² | $0.12/дм² |
| Минимальная ширина трассировки | 50мкм | 75мкм |
| Тепловые циклы | 3,000 | 1,500 |
| Потеря сигнала (@10 ГГц) | 0.15дБ/дюйм | 0.25дБ/дюйм |
3. Процесс заполнения паяной маски
3.1 Модель потока чернил при отрицательной визуализации
Заполнение маски для пая:
Q = (πr⁴Δp)/(8мкл) × (1 – e^(-T/T.))
С постоянным временем t = MR²/(4в), Объяснение 50% Скорость заполнения в полуфинальных VIA.
3.2 Примерное исследование неудачи HASL
Неполненные варки в платы 5 г базовой станции вызвали жестяные бусы, смоделировано уравнением Аррениуса:
t_f = a × exp(EA/(кт))
Тестирование показало, что MTBF упал с 10 к 2.3 Годы при 85 ° С/85%РС. Реализация 0,30 мм VIAS с отверстиями для маски припоя ≤(через диаметр +0,08 мм) уменьшенные дефекты жестяных бусин от 12% к 0.7%.
4. Продвинутый с помощью технологий наполнения
4.1 Проводящая начинка для экранирования EMI
Серебряная эпоксидная наполнение повышает эффективность экранирования (С):
SE = 20log(1/(1-ведущий)) + 10бревно(Н)
В 80% скорость заполнения (P = 0,8), SE улучшается на 18 дБ на 1 ГГц.
4.2 Наполненное наполнение меди для целостности сигнала
Наполненная медью через импеданс:
Z0 = (87/√ε_r)ведущий(5.98час/(0.8W+T.))
Медные столбы уменьшают изменение импеданса с ± 15% до ± 5%, Понижение BER с 10⁻⁶ до 10⁻² при 28 Гбит / с.
5. Процесс решения принятия решений
Общая стоимость владения (TCO) Анализ
- Бытовая электроника: Заполнение маски при приповке предлагает самую 5-летнюю TCO
- Автомобильная промышленность: Смола + Частичное заполнение меди обеспечивает надежность
- Военный: Медные колонны оптимизируют целостность сигнала
Заключение
Через заполнение для приложений 6G
По мере того, как частоты терагерца требуют субэд-50 мкм посредством точности, нано-серебристое спекание возникает как прорыв. Освоение через физику наполнения будет стимулировать следующее поколение высокочастотная печатная плата инновации.