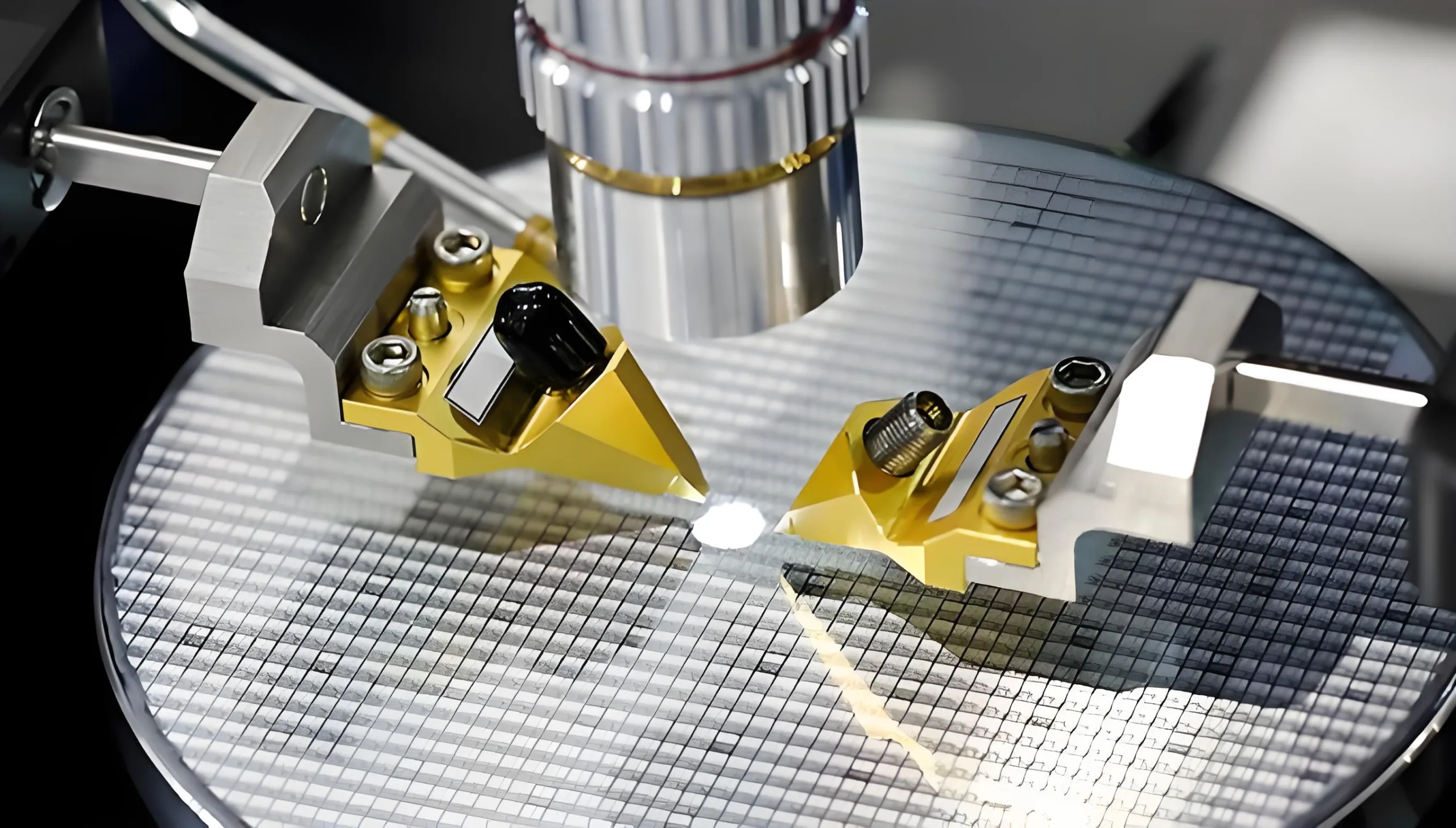
บรรจุภัณฑ์ TSV และ TGV 3D
เทคโนโลยีบรรจุภัณฑ์, เป็นหนึ่งในกระบวนการหลักในอุตสาหกรรมเซมิคอนดักเตอร์, ได้เห็นแนวโน้มของการย่อขนาด, ความหนาแน่นสูง, และมัลติฟังก์ชั่นในผลิตภัณฑ์อิเล็กทรอนิกส์. ตั้งแต่บรรจุภัณฑ์ผ่านรูถึงบรรจุภัณฑ์ที่ติดตั้งพื้นผิว, แล้วไปที่ BGA, CSP, SCM, MCM, WLP, 3D บรรจุภัณฑ์, และจิบ, ทุกความก้าวหน้าในเทคโนโลยีบรรจุภัณฑ์ได้ผลักดันการก้าวกระโดดที่สำคัญในผลิตภัณฑ์อิเล็กทรอนิกส์. ในบรรดาเทคโนโลยีบรรจุภัณฑ์เหล่านี้, ผ่านซิลิกอนผ่าน (TSV) และผ่านกระจกผ่าน (TGV) เทคโนโลยีไม่ต้องสงสัยเลยว่าสองกุญแจสำคัญในการปลดล็อกยุคใหม่ของบรรจุภัณฑ์ 3D.
กระบวนการพัฒนาเทคโนโลยีบรรจุภัณฑ์ 3 มิติ
3D บรรจุภัณฑ์: แบบฟอร์มและวิธีการเชื่อมต่อโครงข่าย
3D บรรจุภัณฑ์ส่วนใหญ่แบ่งออกเป็นสามประเภท: ประเภทที่ฝังอยู่, ประเภทสารตั้งต้นที่ใช้งานอยู่, และประเภทซ้อนกัน. ประเภทที่ฝังอยู่อุปกรณ์ฝังภายในสายไฟหลายชั้นหรือภายในสารตั้งต้น. ประเภทสารตั้งต้นที่ใช้งานอยู่แรกรวมส่วนประกอบเข้ากับสารตั้งต้นเวเฟอร์เพื่อสร้างสารตั้งต้นที่ใช้งานอยู่, จากนั้นจัดเรียงการเชื่อมต่อหลายชั้น. ประเภทซ้อนเกี่ยวข้องกับเวเฟอร์ซิลิคอนซ้อนหรือชิป. 3วิธีการเชื่อมต่อโครงข่าย D รวมถึงการเชื่อมสายไฟ, ชิป, TSV, และตัวนำฟิล์มบาง. ในหมู่พวกเขา, TSV เปิดใช้งานการเชื่อมต่อระหว่างชิปในแนวตั้ง, ทำหน้าที่เป็นเทคโนโลยีที่สำคัญในการบรรลุการย่อขนาด, ความหนาแน่นสูง, ประสิทธิภาพสูง, และมัลติฟังก์ชั่นในบรรจุภัณฑ์โครงสร้างที่แตกต่างกัน.
แผนผังไดอะแกรมของเทคโนโลยีบรรจุภัณฑ์ 3 มิติ
เทคโนโลยี TSV: กระบวนการและกระแสการผลิต
เทคโนโลยี TSV สร้างเส้นทางสัญญาณแนวตั้งผ่านพื้นผิว, การเชื่อมต่อ RDL (การแจกจ่ายใหม่) ที่ด้านบนและด้านล่างของสารตั้งต้น, การสร้างเส้นทางตัวนำ 3 มิติ. ขึ้นอยู่กับลำดับที่มีแนวหน้าของบรรทัด (ฟีล) และด้านหลังของบรรทัด (การเป็นทาส) กระบวนการ, กระบวนการ TSV สามารถแบ่งออกเป็นสามกระแสการผลิตกระแสหลัก: ผ่านครั้งแรก, เวียห์เดิล, และ veialast.
เทคโนโลยี TSV: กระบวนการและขั้นตอนการผลิต
ผ่านกระบวนการแกะสลัก
กระบวนการแกะสลักผ่านเป็นสิ่งสำคัญสำหรับการผลิตโครงสร้าง TSV. ตอนนี้, มีกระบวนการแกะสลักหลักสี่ประการ: การแกะสลักไอออนปฏิกิริยาลึก (สาม), การแกะสลักเปียก, การแกะสลักด้วยไฟฟ้า (paece), และการขุดเจาะเลเซอร์.
สาม
อัตราส่วนที่สูงผ่านรูที่เกิดจากการแกะสลักกระบวนการ drie
กระบวนการแกะสลัก TSV ที่ใช้กันมากที่สุดสำหรับการบรรลุอัตราส่วนสูงผ่านโครงสร้าง. กระบวนการ Bosch, Drie รุ่นที่ได้รับการปรับปรุง, ใช้ก๊าซ SF6 และ C4F8 เพื่อป้องกันการพาส, เหมาะสำหรับการแกะสลักอัตราส่วนอัตราส่วนสูง. อย่างไรก็ตาม, กระบวนการ DRIE ส่งผลให้ Sidewall ราบรื่นไม่ดี, การสร้างข้อบกพร่องรูปหอยเชลล์.
การแกะสลักเปียก
การแกะสลักเปียก
รวมหน้ากากกับการแกะสลักเคมี, ทำให้กระบวนการง่ายและเหมาะสำหรับการผลิตมวลต่ำ. อย่างไรก็ตาม, เนื่องจากอิทธิพลของการวางแนวผลึกเวเฟอร์ซิลิคอน, vias สลักไม่ได้เป็นแนวตั้ง, จำกัด แอปพลิเคชัน.
paece
ใช้แสงอัลตราไวโอเลตเพื่อเร่งการสร้างคู่อิเล็กตรอนรู, การเร่งกระบวนการแกะสลักทางเคมีไฟฟ้า, เหมาะสำหรับการแกะสลักอัตราส่วนความสูงเป็นพิเศษผ่านทางโครงสร้าง, แต่ด้วยความสามารถในการควบคุมความลึกของ Etch ที่อ่อนแอกว่า.
การขุดเจาะเลเซอร์
การขุดเจาะเลเซอร์
ใช้คานเลเซอร์พลังงานสูงเพื่อละลายและระเหยวัสดุในพื้นที่ที่กำหนด, การสร้างอัตราส่วนภาพสูง, Vias ข้างแนวตั้ง, แต่ผนังหลุมมีความไวต่อความเสียหายทางความร้อนที่มีผลต่อความน่าเชื่อถือ.
ผ่านทางเทคโนโลยีผ่านเทคโนโลยี
กระบวนการสะสมซับ
กระบวนการสะสมซับจะดำเนินการหลังจากผ่านการแกะสลัก. ชั้นซับที่ฝาก, โดยทั่วไปคือออกไซด์เช่น SiO2, ทำหน้าที่แยกการรั่วไหลของกระแสไฟฟ้าโดยตรง. กระบวนการสะสมจะต้องเป็นไปตามข้อกำหนดแรงดันไฟฟ้าของชั้นฉนวนและทำให้แน่ใจว่ามีความสอดคล้องที่แข็งแกร่งและการยึดเกาะที่ดีระหว่างเลเยอร์.
พีอีซีวีดี
ใช้เพื่อฝาก SiO2 หรือ SINX เป็นชั้นฉนวน, เหมาะสำหรับกระบวนการ Viamiddle และ Vialast, สร้างความมั่นใจในความเข้ากันได้กับวัสดุ beol.
อัลดี้
ฝาก Al2O3 เพื่อให้ได้ชั้นฉนวนหนาแน่น.
กระบวนการเติมโลหะ
กระบวนการเติม TSV กำหนดคุณภาพ TSV, ด้วยทองแดงที่ชุบด้วยไฟฟ้าเป็นวัสดุหลัก. ขึ้นอยู่กับความแตกต่างในการกระจายอัตราการชุบด้วยไฟฟ้า, มันสามารถแบ่งออกเป็นแบบไม่ลงรอยกัน, สอดคล้องกัน, วิสาสะ, และวิธีการชุบด้วยไฟฟ้าจากล่างขึ้นบน.
การชุบด้วยไฟฟ้าที่สอดคล้องกัน
สร้างความมั่นใจในการเติมเต็มของ Cu ions ที่สม่ำเสมอ, การทำให้อัตราการชุบด้วยไฟฟ้าโดยทั่วไปสอดคล้องกันทุกตำแหน่งภายใน VIA, ทิ้งตะเข็บไว้ข้างใน.
การชุบด้วยไฟฟ้า
โดยการควบคุมการจัดหาไอออน Cu, อัตราการเติมด้านล่างสูงกว่าตำแหน่งอื่น ๆ เล็กน้อย, กำจัดตะเข็บและบรรลุการเติมที่ไม่มีโมฆะ.
การชุบด้วยไฟฟ้าจากล่างขึ้นบน
อัตราการชุบด้วยไฟฟ้าจะถูกระงับเป็นศูนย์ยกเว้นที่ด้านล่าง, การชุบด้วยไฟฟ้าค่อยๆจากด้านล่างขึ้นไปด้านบน, ลดเวลาการชุบด้วยไฟฟ้า.
เทคโนโลยีกระบวนการ RDL
เทคโนโลยี RDL เป็นเทคโนโลยีพื้นฐานที่สำคัญในบรรจุภัณฑ์ 3 มิติ, ใช้เพื่อสร้างการเชื่อมต่อระหว่างโลหะสำหรับการกำหนดพอร์ตใหม่หรือการเชื่อมต่อระหว่างแพ็คเกจระหว่างแพ็คเกจ. มีกระบวนการ RDL หลักสองกระบวนการ: ขึ้นอยู่กับโพลีเมอร์ที่ไวต่อแสงและ Cu Damascene.
แผนภาพการไหลของกระบวนการ RDL
กระบวนการ RDL ขึ้นอยู่กับโพลีเมอร์ที่ไวต่อแสง
เกี่ยวข้องกับเรซิน Pi หรือ BCB แบบสปินเคลือบ, การถ่ายภาพด้วยแสง, การแกะสลัก, PVD สปัตเตอร์ของชั้นกำแพง TI/CU/ชั้นเมล็ด, และการรวม photolithography เข้ากับ Cu electroplating เพื่อผลิต RDL.
กับกระบวนการของดามัสกาน
เงินฝากครั้งแรก SiO2 หรือ SI3N4 เป็นชั้นฉนวน, สร้างหน้าต่างผ่านการถ่ายภาพและการแกะสลัก, sputters ti/cu, และใช้ CMP เพื่อลดความหนาที่ต้องการ.
กระบวนการ IPD และเทคโนโลยี TGV: เส้นทางใหม่สำหรับอุปกรณ์พาสซีฟ 3D
อุปกรณ์พาสซีฟในตัว (IPD) กระบวนการสร้างห้องสมุดของอุปกรณ์พาสซีฟที่สามารถเรียกได้ตามต้องการโดยการรวมอุปกรณ์พาสซีฟเข้ากับสารตั้งต้นแยกต่างหาก. IPD เสนอข้อดีของต้นทุนต่ำและความยืดหยุ่นสูง, เหมาะอย่างยิ่งสำหรับการผลิตอุปกรณ์พาสซีฟ TSV 3D. IPD สามารถใช้วัสดุพื้นผิวต่างๆ, รวมถึงศรี, ทั้งคู่, เซรามิก Al2O3, พื้นผิวแก้ว, ฯลฯ, ขยายความยืดหยุ่นในการออกแบบ.
กระบวนการอุปกรณ์พาสซีฟแบบรวม
3ตัวเหนี่ยวนำ D ที่ผลิตจากกระบวนการ IPD และ TGV แสดงลักษณะฉนวนที่เหนือกว่าเนื่องจากความต้านทานที่สูงขึ้นของพื้นผิวแก้วเมื่อเทียบกับวัสดุเซมิคอนดักเตอร์ทั่วไป, ส่งผลให้สูญเสียการแทรกต่ำ. นอกจากนี้, ตัวเก็บประจุ MIM สามารถประดิษฐ์บน IPDS พื้นผิวแก้ว, เชื่อมต่อกับตัวเหนี่ยวนำ TGV 3D เพื่อสร้างโครงสร้างตัวกรองแบบพาสซีฟ 3 มิติ.
บทสรุป
เป็นเทคโนโลยีสำคัญในบรรจุภัณฑ์ 3 มิติ, เทคโนโลยี TSV และ TGV ไม่เพียง แต่ขับเคลื่อนนวัตกรรมในเทคโนโลยีบรรจุภัณฑ์เซมิคอนดักเตอร์เท่านั้น แต่ยังให้การสนับสนุนที่แข็งแกร่งสำหรับการย่อขนาด, ความหนาแน่นสูง, และประสิทธิภาพสูงของผลิตภัณฑ์อิเล็กทรอนิกส์. ด้วยการพัฒนาเทคโนโลยีอย่างต่อเนื่อง, TSV และ TGV จะมีบทบาทสำคัญมากขึ้นในผลิตภัณฑ์อิเล็กทรอนิกส์ในอนาคต, นำในยุคใหม่ของบรรจุภัณฑ์ 3 มิติ. ผ่านการสำรวจและนวัตกรรมอย่างต่อเนื่อง, เรามีเหตุผลที่จะเชื่อว่าเทคโนโลยี TSV และ TGV จะทำให้มนุษย์ฉลาดขึ้น, สะดวกยิ่งขึ้น, และวิถีชีวิตทางอิเล็กทรอนิกส์ที่มีประสิทธิภาพ.