Produktübersicht: What is an HDI IC Substrate Board?
An HDI IC Substrate Board is a critical, High-End Leiterplatte engineered specifically for semiconductor package interconnection. It acts as the essential interface, providing electrical connectivity, Stromverteilung, and mechanical support between a finely-pitched silicon die and a standard motherboard Leiterplatte. UGPCB delivers high-reliability, advanced HDI IC Substrate manufacturing, meeting the stringent demands of applications from consumer electronics to high-performance computing.

This board, built with SI10U material in a 6-Schicht (2+2+2) construction and a slim profile of 0.6mm, exemplifies state-of-the-art HDI Technologie. With a 35x35mm unit size, it features a 0.1mm minimum laser via diameter, 30μm minimum trace width / 70μm minimum spacing, Und Enepic (Elektrololes Nickel Elektrololless Palladium Immersion Gold) Oberflächenbeschaffung, making it an ideal solution for packaging high-speed, Hochfrequenz, and highly integrated chips.
In-Depth Analysis: Design, Funktion, and Applications
Core Definition & Arbeitsprinzip
The HDI IC Substrate is designed to “fan-out” the dense array of micro-bumps from a semiconductor die, redistributing the connections to a larger pitch compatible with standard Leiterplattenbestückung processes like BGA (Kugelgitter-Array) Montage.
The working principle follows this chain: Die → Microbumps → HDI IC Substrate (for signal redistribution & Zusammenschaltung) → Solder Balls (BGA/CSP) → Mainboard PCB. It is pivotal for signal integrity, power delivery, und thermisches Management.
Wichtige Designüberlegungen
-
Stack-up & Impedanzkontrolle: The 6-layer (2+2+2) build-up is a classic design for high routing density. Precise impedance calculation (typischerweise 50 Ω Single-Ended oder 100 Ω Differential) is crucial for signal integrity.
-
Micro-via Reliability: 0.1mm (100μm) laser-drilled micro-vias are key for interconnect density. Via shape, Kupferbeschichtung, and fill process must be optimized for thermal cycle reliability.
-
Fine-Line Fabrication: 30μm trace width and 70μm spacing are core metrics of process capability, directly impacting I/O density and electrical performance.
-
Thermal & Mechanical Management: The selection of SI10U material considers its Coefficient of Thermal Expansion (CTE) matching with silicon to minimize thermal stress and enhance product longevity.
Primary Materials & Leistungseigenschaften
-
Kernmaterial: Si10U. A high-performance laminate offering low dielectric constant (Dk), geringer Verlustfaktor (Df), high glass transition temperature (Tg), und ausgezeichnete dimensionale Stabilität, ideal for high-speed, high-frequency applications.
-
Lötmaske: PSR-4000 AUS308. A high-resolution, high-reliability Liquid Photoimageable Solder Mask (LPSM) that provides precise coverage, excellent insulation, and chemical resistance.
-
Oberflächenbeschaffung: Enepic. This finish deposits sequential layers of Nickel, Palladium, and Gold. Nickel acts as a diffusion barrier, Palladium prevents nickel corrosion, and the thin gold layer offers superior solderability and wire-bonding capability, perfect for fine-pitch pads.
-
Performance Summary: Hohe Dichte, hohe Geschwindigkeit, hohe Zuverlässigkeit, Ausgezeichnetes thermisches Management, and superior signal integrity.
Einstufung & Anwendungsszenarien
HDI IC Substrates are categorized by technology and application:
-
Nach Technologie: With core (z.B., this 6L build-up) or coreless types.
-
Durch Anwendung:
-
Advanced Processors: CPU, GPU, AI accelerator chips requiring maximum routing density and signal speed.
-
Mobile & Rf: Smartphone Application Processors (AP) und HF -Module, where miniaturization and thin profiles (0.6mm) are critical.
-
Erinnerung: Interface substrates for High Bandwidth Memory (HBM).
-
Networking & Automobil: High-speed switch chips and ADAS domain controllers.
-
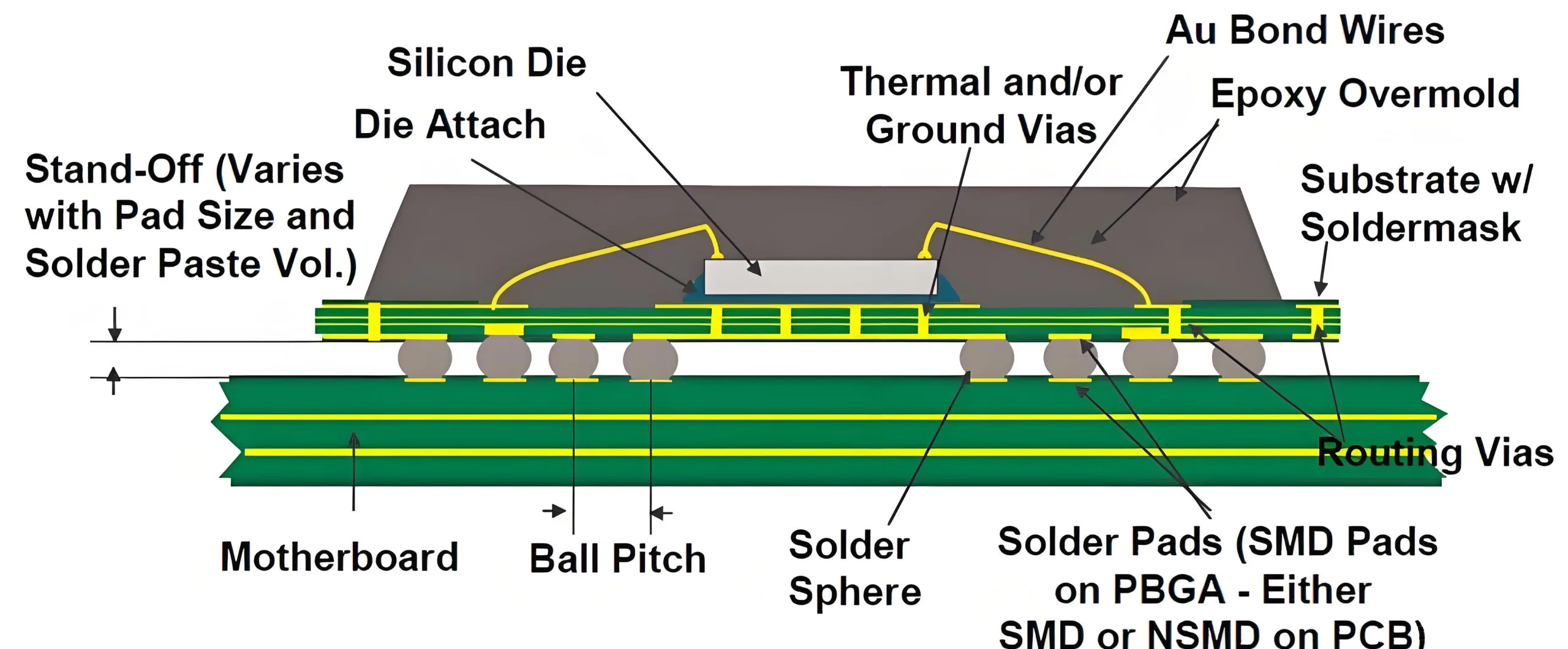
UGPCB’s Manufacturing Process & Qualitätssicherung
UGPCB’s production integrates leading-edge processes compliant with IPC standards:
-
Laserbohren: UV laser systems create precise 0.1mm micro-vias.
-
Überzug & Via Fill: Advanced pulse plating ensures complete via filling for reliable interconnects.
-
Advanced Imaging: High-end exposure systems and high-resolution dry film achieve 30/70μm line definition.
-
Laminierung: Precise alignment and pressing of multiple core layers and prepreg (Pp).
-
Oberflächenbearbeitung: Application of the Enepic coating for optimal solderability.
-
Umfassende Tests: Utilizes AOI (Automatisierte optische Inspektion), Flying-Probe-Tests, and impedance testing to guarantee compliance.
Unser one-stop Leiterplatte Service capability extends from IC-Substrat Herstellung bis nachfolgend SMT -Baugruppe Und Testen, offering a complete packaging solution.
Why Choose UGPCB for Your HDI IC Substrate?
-
Erweiterte Prozessfähigkeit: Proven expertise in 30/70μm trace/space Und 0.1mm micro-via Technologie.
-
Materials Expertise: In-depth knowledge of advanced materials like Si10U to recommend optimal solutions.
-
Uncompromising Quality: Stringent, automotive-grade quality control throughout the entire process.
-
One-Stop-Lösung: We are more than a PCB fabricator; we are your PCBA partner, offering design support, Herstellung, und Montage.
-
Expert Support: Dedicated engineering team provides DFM (Design für die Herstellung) analysis and technical consultation.
Holen Sie sich jetzt Ihre benutzerdefinierte Lösung
Whether you are developing the next HPC platform, 5G-Infrastruktur, oder ADAS system, UGPCB’s professional HDI IC Substrate manufacturing Und PCBA assembly services are your foundation for success.
Contact us today for a free technical consultation and quote! Let our experts help you enhance product performance through optimized IC substrate design and reliable Leiterplattenfertigung Prozesse.
 UGPCB-LOGO
UGPCB-LOGO