
Controllo vuoto BGA
Nel mondo della produzione di PCB di precisione, Ogni dettaglio è cruciale, Soprattutto quando si tratta di BGA (Array a sfera) confezione. BGA vuoti, o piccole cavità all'interno delle palle di saldatura, può sembrare insignificante ma può nascondere gravi rischi che influiscono sull'affidabilità del prodotto. Questo articolo approfondirà come ridurre il verificarsi di vuoti BGA attraverso un meticoloso controllo del processo, Garantire la stabilità e la sicurezza dei collegamenti elettronici.
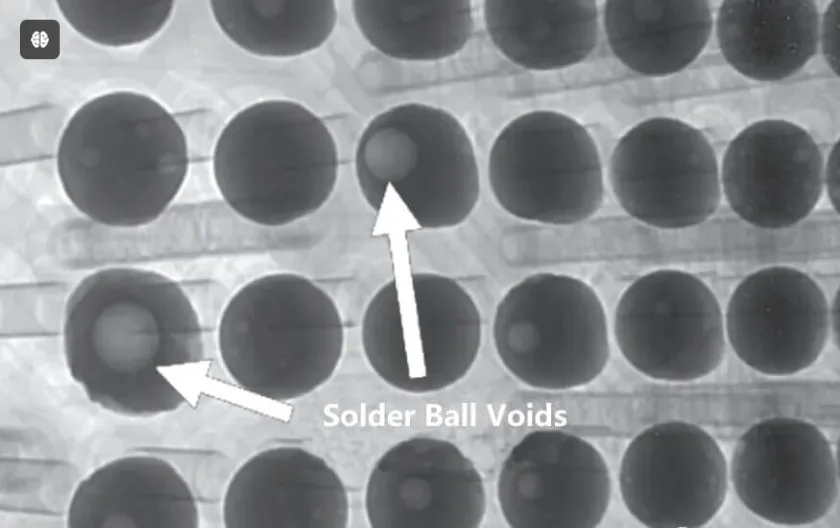
BGA vuoto
La posizione dei vuoti: Il punto chiave
Primo, Chiariamo una cosa: Non tutti i vuoti sono ugualmente pericolosi. Vuoti all'interno delle palline di saldatura, Se non rappresentano una minaccia diretta per l'integrità strutturale, potrebbe avere un impatto limitato. Tuttavia, Quando i vuoti compaiono all'interfaccia tra il substrato di sfera di saldatura e pacchetto o la palla di saldatura e il PCB, La situazione è drasticamente diversa. Questi vuoti di interfaccia fungono da potenziali acceleratori di crack; Una volta sottoposto a forze esterne, Possono portare a crepe per giunti di saldatura, influire gravemente l'affidabilità del prodotto e la durata della vita.

Diagramma di flusso della valutazione del vuoto
Comprendere intuitivamente il processo di valutazione del vuoto, Introduciamo la figura A-1. Questo diagramma di flusso descrive in dettaglio ogni passo dall'identificazione del vuoto alle azioni corrispondenti, Servire come strumento efficace per garantire il controllo del processo.
Indicatori di misura correttivi: Azioni precise

Indice di misura correttiva A-1 per le piastre di collegamento utilizzate con 1.5, 1.27 o 1,0 mm di passo
Per BGA con tiri diversi, Abbiamo sviluppato indicatori di misura correttiva dettagliati, come mostrato nelle tabelle da A-1 ad A-3 (il cui contenuto è riassunto qui in forma di testo). Basato sugli standard IPC, Queste tabelle combinano la posizione del vuoto, misurare, e quantità per fornire linee guida di azione specifiche per BGA di diversi tiri. Ad esempio, La tabella A-1 elenca le misure consigliate per diversi tipi e quantità di vuoti per BGA con piazzole di 1,5 mm, 1.27mm, e 1,0 mm, Mirando a mantenere l'affidabilità della connessione.
Descrizione caratteristica del processo: Controllo scientifico
La descrizione caratteristica del processo è al centro della riduzione dei vuoti. In base alla dimensione del vuoto e seguendo i suggerimenti sul diagramma di flusso, combinato con la struttura a tre livelli negli standard IPC, Considera la posizione vuota, misurare, e quantità per stabilire le misure di controllo necessarie. Queste misure si applicano non solo all'ottimizzazione continua dei prodotti esistenti, ma anche alle introduzioni di nuovi prodotti, qualifiche di prodotto e di processo, Modifiche alla configurazione dell'attrezzatura, qualifiche componenti, e risposte al feedback dei clienti.
Sfide e risposte al BGA

Indice di misura correttiva A-2 per le piastre di collegamento utilizzate con 1.5, 1.27 o 1,0 mm di passo
Mentre BGA Pitch continua a diminuire, Così fa l'area di connessione, posando richieste più elevate sul controllo del vuoto. La tabella A-2 affronta specificamente BGAS con piazzole di 0,8 mm, 0.65mm, e 0,5 mm, Fornire misure correttive dettagliate. Per BGA di titoli fine, Anche i vuoti minori possono influire significativamente sull'affidabilità della connessione. Perciò, Misure di controllo più rigorose, come ridurre la dimensione del vuoto, deve essere preso per compensare la riduzione dell'area di connessione.
Via-in-pad design e controllo vuoto

A-3 Indice di misura correttiva per le piastre di collegamento utilizzate con 1.5, 1.27 o 1,0 mm di passo
Nei disegni con tiri più piccoli, Le microvia e i disegni via-in-pad diventano la chiave per ottenere uno spazio di routing sufficiente. Tuttavia, Questo introduce nuove sfide: Come garantire che questi progetti non aumentino il rischio di vuoti? Figura A-2 (Immagina uno schema che mostra come le crepe possono propagare dai vuoti) dimostra come i vuoti possono influire sull'affidabilità dell'articolazione della saldatura. Per evitare questo, I progetti via-in-pad richiedono ulteriori restrizioni sulle tolleranze del vuoto, come mostrato nella tabella A-3.
Vuoto standard di controllo del processo

Vuoto in BGA
La dimensione e il numero di vuoti sono indicatori importanti per valutare l'efficacia del controllo del processo. Il verificarsi di routine dei vuoti indica una perdita di controllo del processo, richiedere strumenti necessari per migliorare i processi e i materiali. Basato su dimensioni e pitch, Definiamo le caratteristiche accettabili dei vuoti per garantire l'affidabilità del prodotto finale.
I dettagli determinano il successo o il fallimento: Considerazione della forma della sfera di saldatura

Infine, L'impatto della forma della sfera di saldatura sul controllo del vuoto non può essere ignorato. In palline di saldatura crollate, La palla diventa ellissoidale piuttosto che una sfera uniforme, conducendo a un diametro del giunto di saldatura al centro della sfera che di solito è più grande del diametro dalla sfera all'interfaccia del pad di connessione. Questo cambiamento di forma influisce sulla dimensione e la distribuzione dei vuoti, quindi, Quando si impostano gli standard, Devono essere prese in considerazione diverse combinazioni di dimensioni della palla di saldatura e del pad di connessione.
Conclusione: La fusione dell'arte e della scienza
Ridurre i vuoti BGA attraverso il controllo del processo è una fusione di arte e scienza. Richiede sia una profonda conoscenza dell'ingegneria elettronica che meticolosa artigianato. Attraverso azioni precise e controllo scientifico, Possiamo ridurre efficacemente il verificarsi di vuoti, Garantire la stabilità e la sicurezza dei collegamenti elettronici. In questa era impegnativa e opportuno, Lavoriamo insieme per esplorare più incognite, Crea prodotti elettronici più affidabili, e contribuire al progresso tecnologico umano.
 LOGO UGPCB
LOGO UGPCB

