No coração dos chips de última geração está um substrato, dificilmente do tamanho de uma unha, mas atravessado por dezenas de milhares de circuitos intrincados, ditando silenciosamente o desempenho e a estabilidade de todo o sistema.
O Substrato do pacote IC é o principal transportador em embalagens de chips semicondutores. É responsável por estabelecer conexões de sinais elétricos, entrega de energia, suporte físico, dissipação de calor, e proteção entre a matriz semicondutora e o externo placa de circuito impresso (PCB). Seu desempenho determina diretamente a integridade do sinal do chip, eficiência térmica, e a confiabilidade do produto final.
Substratos IC utilizando LGA (Matriz de grade terrestre) embalagem, com seu design exclusivo de pads planos na parte inferior, estão se tornando uma escolha crítica para alto desempenho, embalagem de chips de alta densidade.

01 Visão geral do produto: Definição & Especificações principais
O substrato do pacote IC, frequentemente chamado de portador IC, é o material-chave de maior valor no processo de embalagem de chips. Ele atua como tradutor e ponte entre o mundo microscópico da matriz semicondutora e o mundo macroscópico dos circuitos PCB..
Simplesmente coloque, através de seus microcircuitos internos de precisão, ele transforma e expande as almofadas de eletrodos densamente compactadas (em uma escala de mícron) na matriz em uma escala adequada para soldagem e conexão à placa de circuito impresso principal.
O substrato LGA IC da UGPCB é uma operadora de interconexão de ponta projetada especificamente para alta densidade, chips de alto desempenho. As especificações básicas de seu modelo básico definem seus limites de capacidade.
A tabela abaixo descreve claramente os principais parâmetros físicos e elétricos do produto:
| Categoria de parâmetro | Especificação | Significado & Implicação |
|---|---|---|
| Construção Básica | Material: SI165 / Camadas: 4 / Grossura: 0.4milímetros | Utiliza laminado de alto desempenho para finos, interconexões multicamadas, atendendo aos requisitos de espaço compacto. |
| Dimensões do contorno | Tamanho da unidade: 8mm × 8 mm | Adequado para pacote de escala de chip (Csp) ou embalagens miniaturizadas, economizando espaço geral do dispositivo. |
| Precisão de linha | Min. Largura da linha: 40μm / Min. Espaçamento entre linhas: 100μm | Representa interconexão de alta densidade (IDH) capacidade, permitindo mais rotas de sinal em uma área limitada. |
| Tecnologia de Microvia | Min. Tamanho da broca: 0.1milímetros (100μm) | Permite condução camada a camada de alta densidade, fundamental para interconexões multicamadas complexas. |
| Acabamento superficial | Máscara de solda: PSR-2000 BL500 / Tratamento de superfície: Enepic | Garante a confiabilidade da soldagem. A ENEPIG oferece um excelente, superfície soldável de longa duração. |
A marca registrada da embalagem LGA é o arranjo de almofadas planas de metal (Terras) em uma matriz completa ou parcial na parte inferior do substrato, ao contrário das bolas de solda de um BGA (Array da grade de bola).
Este projeto oferece melhor controle de coplanaridade e caminhos elétricos mais curtos quando soldado à PCB, beneficiando a transmissão de sinais de alta frequência e alta velocidade.
02 Aprofundamento técnico: Estrutura, Projeto & Princípio Operacional
Um substrato LGA IC é um feito complexo de engenharia de microssistemas. Sua estrutura central normalmente compreende, de cima para baixo: a área de fixação da matriz (para conexões Flip Chip ou Wire Bond), camadas de roteamento HDI multicamadas, componentes passivos incorporados (opcional), e o conjunto de pads LGA na parte inferior.
Foco no design centra-se em alcançar interconexão elétrica eficiente e confiável dentro de uma área minúscula. A largura mínima da linha de 40 μm e o espaçamento de 100 μm são regras básicas de design, necessitando de cálculos precisos para a capacidade de carga atual, controle de impedância, e sinalizar diafonia.
Tecnologia de incorporação é uma direção de design de ponta. Envolve a incorporação de componentes passivos como resistores e capacitores, ou mesmo IC morre, diretamente dentro das camadas de substrato. Isso encurta significativamente os caminhos do circuito, melhora o desempenho elétrico, aumenta a confiabilidade, e conserva o espaço da superfície.
Princípio Operacional pode ser comparado a um cruzamento rodoviário para sinais e energia. Os sinais gerados pelo chip entram na camada superior do substrato através de micro-saliências ou fios de ouro. Eles são então redistribuídos e encaminhados através dos intrincados, circuito multicamadas antes de ser transmitido de forma estável e eficiente para a placa-mãe através dos pads LGA inferiores.
Ao longo deste processo, a baixa perda dielétrica do próprio substrato, impedância estável, e excelente desempenho térmico são essenciais para evitar distorção de sinal, atenuação de potência, e superaquecimento de chips.
03 Ciência dos Materiais: O “Carne & Sangue” do Substrato
A fonte do desempenho de um substrato está nos materiais que o constituem. O material central do nosso substrato é SI165, um laminado à base de resina orgânica de alto desempenho. No domínio do substrato IC, o laminado é o componente de maior custo, normalmente contabilizando mais 30% do custo total. Suas propriedades determinam a eletricidade do substrato, térmico, e desempenho mecânico.
Os atuais laminados orgânicos de alta qualidade incluem:
-
BT (Bismaleimida Triazina) Resina: Aguenta 70% participação no mercado global. Conhecido pela alta resistência ao calor, módulo alto, e baixo coeficiente de expansão térmica (CTE), é amplamente utilizado em embalagens de chips de memória.
-
ABF (Filme de construção da Ajinomoto): Fornecido principalmente pela japonesa Ajinomoto. Preferido para chips lógicos de última geração (CPUs, GPU) devido ao seu isolamento superior e adequação para padrões de linhas extremamente finas.
Além do laminado central, folha de cobre forma os traços condutores, pré-impregnados especiais são usados para laminação, enquanto o Máscara de solda PSR-2000 BL500 e Acabamento superficial ENEPIG formar a barreira protetora final e soldável.
Substratos LGA de alta precisão são a base para a miniaturização de chips e melhoria de desempenho, com densidades de fiação interna que excedem em muito as dos PCBs padrão.
04 Arte de Fabricação: A jornada da matéria-prima ao componente de precisão
A fabricação de substratos IC representa o segmento mais complexo e que exige precisão Fabricação de PCB. Embora seu fluxo de processo principal compartilhe semelhanças com o padrão produção de PCB multicamadas, os controles de precisão são significativamente mais rigorosos.
Os principais processos incluem imagens da camada interna, laminação, perfuração a laser/mecânica, metalização de furo, imagem da camada externa, acabamento superficial, aplicação de máscara de solda, e roteamento/teste elétrico.
Para atingir larguras de linha de nível de 40μm, a produção emprega predominantemente Processo Semi-Aditivo modificado (Map). Este processo envolve a deposição de uma fina camada de cobre químico no laminado, galvanoplastia para construir o padrão de circuito desejado, e finalmente removendo o excesso de cobre fino. Isso permite linhas mais finas do que os métodos subtrativos tradicionais.
Tecnologia de perfuração também é crucial. Para microvias de nível 100μm, a perfuração mecânica atinge seus limites, fazendo alta precisão perfuração a laser essencial. Ele pode criar menores, vias cegas e enterradas mais precisas.
Acabamento superficial ENEPIG é a etapa crítica final. Ele deposita níquel sequencialmente, Paládio, e ouro, fornecendo soldagem de alto nível e desempenho confiável para os pads LGA.
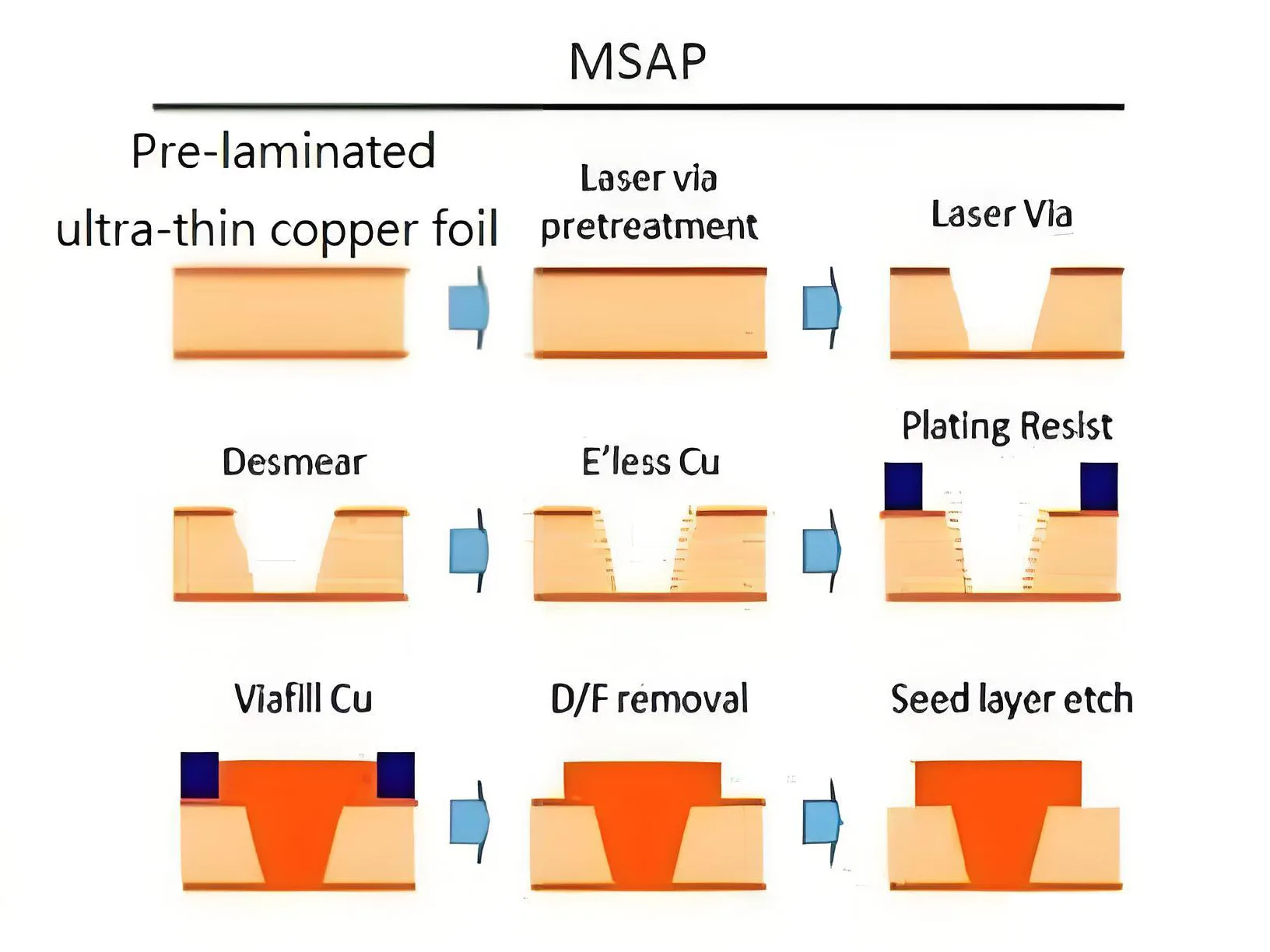
Alt.: Diagrama simplificado ilustrando as etapas do Processo Semi-Aditivo modificado (Map) para criar linhas de circuito ultrafinas.
05 Espectro de Aplicação: Impulsionando diversas indústrias
Os substratos LGA IC não são para um único produto. Como componentes principais, eles estão integrados no coração de quase todos os sistemas eletrônicos avançados.
Seu cenário de aplicações pode ser claramente mapeado com base nos tipos de chips que eles atendem e nas aplicações de uso final:
-
Computação de alto desempenho (HPC): CPUs, GPU, FPGAs. Este setor é o que mais exige dos substratos, exigindo material ABF, densidade de roteamento extremamente alta, e excelente desempenho de alta velocidade. A embalagem LGA é predominante nesses chips de grande porte.
-
Chips de memória: DRAM, Flash NAND. Normalmente usam substratos de material BT maduros. A enorme demanda faz deste um dos pilares do mercado de substratos.
-
Comunicações & RF: 5Módulos RF G/6G, Amplificadores de potência. Requer substratos com baixa perda, características de alta frequência.
-
Sensores & MEMS: Sensores de imagem, Unidades de medição inercial, Microfones. Os substratos devem atender a formas de embalagem específicas e requisitos de confiabilidade.
-
Eletrônica Automotiva & Ai: Chips de direção autônoma, Aceleradores de IA. Um campo de crescimento emergente que exige substratos com alta confiabilidade de nível automotivo e capacidades robustas de processamento de dados.
O mercado global de substratos IC deverá atingir $16.19 bilhão por 2025, impulsionado pelo crescimento vigoroso dessas aplicações downstream.

06 Perspectivas futuras: Evolução tecnológica & Informações do setor
A indústria de substratos evolui em sincronia com, e até dirige, avanços na tecnologia de empacotamento de semicondutores. Duas tendências principais são atualmente proeminentes: Integração de alta densidade e Convergência de embalagens avançadas.
À medida que a Lei de Moore se aproxima dos limites físicos, melhorar o desempenho do sistema através de embalagens avançadas tornou-se um caminho principal. A ascensão de tecnologias como Sistema em pacote (Gole) e 2.5Embalagem D/3D coloca demandas sem precedentes em substratos.
Por exemplo, substratos usados como Interpositores em embalagens 2,5D exigem TSV de densidade extremamente alta (Através do Silício Via) interconecta. Em empilhamento 3D, os substratos devem suportar desafios significativos de tensão térmica e mecânica do empilhamento de múltiplas matrizes.
O florescente Chiplet a tecnologia eleva ainda mais o substrato a um centro de integração de sistemas. Chiplets de diversas funções e nós de processo requerem integração heterogênea através do substrato, apresentando o teste final para complexidade de design, capacidade de roteamento, e integridade do sinal.
Em relação ao cenário competitivo, a indústria global de substratos IC é um oligopólio, com os dez principais players detendo uma participação de mercado combinada superior 80%. O mercado de luxo é dominado por um punhado de empresas no Japão, Coréia do Sul, e Taiwan. As empresas da China continental estão se esforçando para recuperar o atraso, acelerando avanços no mercado de médio a alto padrão, alimentado tanto pelo apoio da política nacional como pela procura do mercado.
As soluções LGA IC Substrate da UGPCB estão na vanguarda desta transformação tecnológica. Um substrato de 8x8mm carrega não apenas circuitos microscópicos, mas serve como uma ponte macroscópica para a computação de alto desempenho da próxima geração.
À medida que a digitalização e a inteligência globais se aprofundam, a demanda insaciável por desempenho de chips continua – de data centers em nuvem a dispositivos inteligentes portáteis.
 LOGOTIPO UGPCB
LOGOTIPO UGPCB