Product Overview: What is an HDI IC Substrate Board?
An HDI IC Substrate Board is a critical, high-end لوحة الدوائر المطبوعة engineered specifically for semiconductor package interconnection. It acts as the essential interface, providing electrical connectivity, توزيع الطاقة, and mechanical support between a finely-pitched silicon die and a standard motherboard ثنائي الفينيل متعدد الكلور. UGPCB delivers high-reliability, advanced HDI IC Substrate manufacturing, meeting the stringent demands of applications from consumer electronics to high-performance computing.

This board, built with SI10U material in a 6-طبقة (2+2+2) construction and a slim profile of 0.6مم, exemplifies state-of-the-art مؤشر التنمية البشرية تكنولوجيا. With a 35x35mm unit size, it features a 0.1mm minimum laser via diameter, 30μm minimum trace width / 70μm minimum spacing, و اينيبيك (Electroless Nickel Electroless Palladium Immersion Gold) surface finish, making it an ideal solution for packaging high-speed, عالية التردد, and highly integrated chips.
In-Depth Analysis: تصميم, وظيفة, and Applications
Core Definition & مبدأ العمل
The HDI IC Substrate is designed to “fan-out” the dense array of micro-bumps from a semiconductor die, redistributing the connections to a larger pitch compatible with standard تجميع ثنائي الفينيل متعدد الكلور processes like BGA (مصفوفة شبكة الكرة) تصاعد.
The working principle follows this chain: Die → Microbumps → HDI IC Substrate (for signal redistribution & interconnection) → Solder Balls (BGA/CSP) → Mainboard PCB. It is pivotal for signal integrity, power delivery, والإدارة الحرارية.
Key Design Considerations
-
Stack-up & السيطرة على المعاوقة: The 6-layer (2+2+2) build-up is a classic design for high routing density. Precise impedance calculation (typically 50Ω single-ended or 100Ω differential) is crucial for signal integrity.
-
Micro-via Reliability: 0.1مم (100ميكرومتر) laser-drilled micro-vias are key for interconnect density. Via shape, copper plating, and fill process must be optimized for thermal cycle reliability.
-
Fine-Line Fabrication: 30μm trace width and 70μm spacing are core metrics of process capability, directly impacting I/O density and electrical performance.
-
Thermal & Mechanical Management: The selection of SI10U material considers its Coefficient of Thermal Expansion (CTE) matching with silicon to minimize thermal stress and enhance product longevity.
Primary Materials & خصائص الأداء
-
Core Material: SI10U. A high-performance laminate offering low dielectric constant (DK), low dissipation factor (ص), high glass transition temperature (تيراغرام), and excellent dimensional stability, ideal for high-speed, high-frequency applications.
-
قناع اللحام: PSR-4000 AUS308. A high-resolution, high-reliability Liquid Photoimageable Solder Mask (LPSM) that provides precise coverage, excellent insulation, and chemical resistance.
-
الانتهاء من السطح: اينيبيك. This finish deposits sequential layers of Nickel, Palladium, and Gold. Nickel acts as a diffusion barrier, Palladium prevents nickel corrosion, and the thin gold layer offers superior solderability and wire-bonding capability, perfect for fine-pitch pads.
-
Performance Summary: High density, سرعة عالية, موثوقية عالية, إدارة حرارية ممتازة, and superior signal integrity.
تصنيف & Application Scenarios
HDI IC Substrates are categorized by technology and application:
-
By Technology: With core (على سبيل المثال, this 6L build-up) or coreless types.
-
By Application:
-
Advanced Processors: وحدة المعالجة المركزية, GPU, AI accelerator chips requiring maximum routing density and signal speed.
-
Mobile & RF: Smartphone Application Processors (AP) and RF modules, where miniaturization and thin profiles (0.6مم) are critical.
-
ذاكرة: Interface substrates for High Bandwidth Memory (HBM).
-
Networking & السيارات: High-speed switch chips and ADAS domain controllers.
-
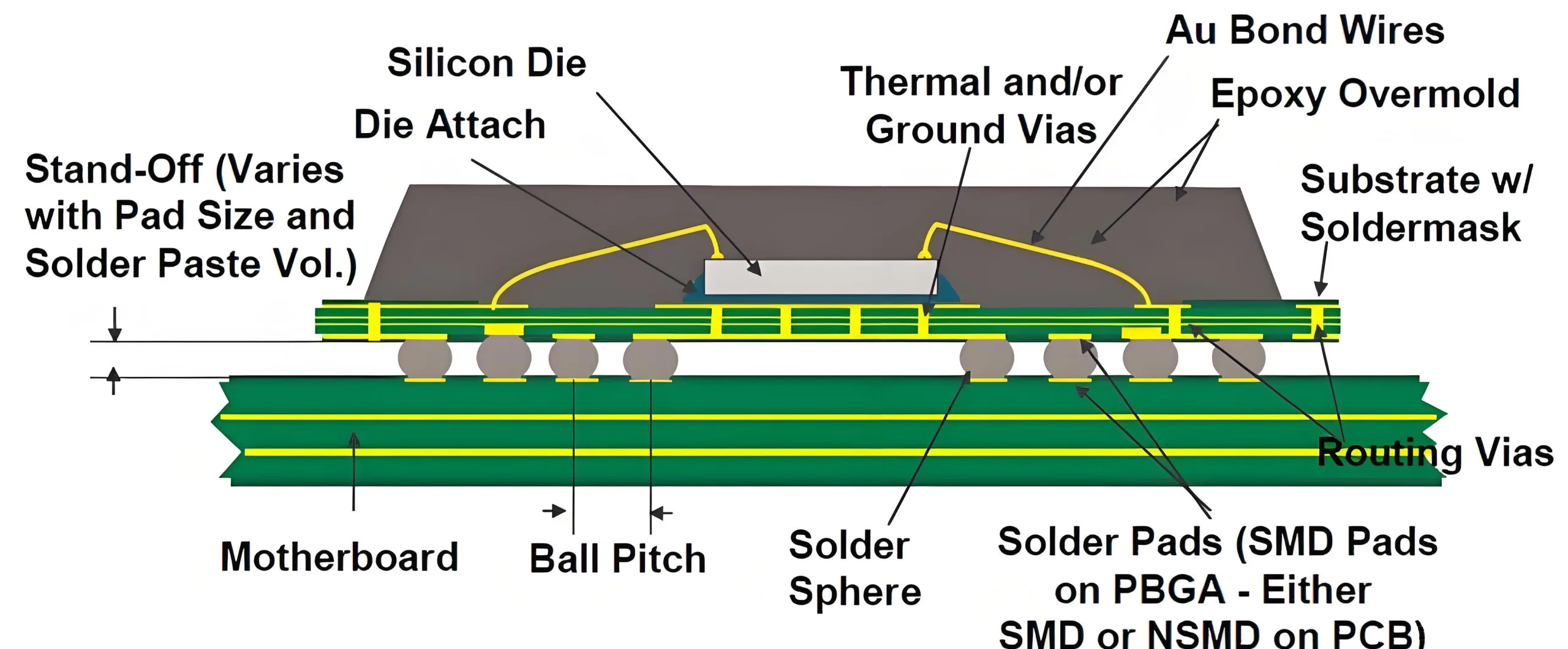
UGPCB’s Manufacturing Process & ضمان الجودة
UGPCB’s production integrates leading-edge processes compliant with IPC standards:
-
حفر الليزر: UV laser systems create precise 0.1mm micro-vias.
-
تصفيح & Via Fill: Advanced pulse plating ensures complete via filling for reliable interconnects.
-
Advanced Imaging: High-end exposure systems and high-resolution dry film achieve 30/70ميكرومتر line definition.
-
التصفيح: Precise alignment and pressing of multiple core layers and prepreg (ص).
-
التشطيب السطح: Application of the اينيبيك coating for optimal solderability.
-
Comprehensive Testing: Utilizes AOI (الفحص البصري الآلي), flying probe testing, and impedance testing to guarantee compliance.
ملكنا one-stop ثنائي الفينيل متعدد الكلور خدمة capability extends from الركيزة IC تصنيع to subsequent تجميع سمت و اختبار, offering a complete packaging solution.
Why Choose UGPCB for Your HDI IC Substrate?
-
Advanced Process Capability: Proven expertise in 30/70μm trace/space و 0.1mm micro-via تكنولوجيا.
-
Materials Expertise: In-depth knowledge of advanced materials like SI10U to recommend optimal solutions.
-
Uncompromising Quality: Stringent, automotive-grade quality control throughout the entire process.
-
One-Stop Solution: We are more than a PCB fabricator; we are your PCBA partner, offering design support, تصنيع, والتجمع.
-
Expert Support: Dedicated engineering team provides سوق دبي المالي (تصميم للتصنيع) analysis and technical consultation.
احصل على الحل المخصص لك الآن
Whether you are developing the next HPC platform, 5البنية التحتية G, أو ADAS system, UGPCB’s professional HDI IC Substrate manufacturing و PCBA assembly services are your foundation for success.
Contact us today for a free technical consultation and quote! Let our experts help you enhance product performance through optimized IC substrate design and reliable تصنيع ثنائي الفينيل متعدد الكلور العمليات.
 شعار UGPCB
شعار UGPCB