La técnica de cortar unidades individuales de las obleas y luego empaquetarlas ha sido durante mucho tiempo la norma para empacar circuitos integrados de semiconductores durante décadas. Sin embargo, Este enfoque no está siendo adoptando actualmente por los principales fabricantes de semiconductores debido a los altos costos de fabricación y al creciente componente de RF de los módulos de hoy en día. De este modo, la aparición de envases a nivel de oblea (WLP) ha llevado a un cambio de paradigma en el desarrollo de envases de bajo costo. WLP es una tecnología de embalaje a nivel de obleas antes del corte de dispositivos de envasado de obleas.
Uso de herramientas y procesos estándar, WLP actúa como una extensión del proceso de fabricación de obleas. Eventualmente, El troquel WLP fabricado tendrá una almohadilla metalizada en la superficie del chip y un punto de soldadura depositado en cada almohadilla antes de cortar la oblea. Este, Sucesivamente, hace que WLP sea compatible con los procesos tradicionales de ensamblaje de PCB y permite la prueba del dispositivo en la oblea misma. Como resultado, es un proceso de costo relativamente bajo y eficiente, especialmente a medida que aumenta el tamaño de la oblea y el troquel de chip se encoge. El tamaño de las obleas ha aumentado en las últimas décadas, de 4, 6, y 8 pulgadas de diámetro para 12 pulgadas. Esto da como resultado un aumento en el número de troqueles por oblea, que reduce los costos de fabricación. En términos de rendimiento eléctrico, WLP es superior a otras tecnologías de empaque, En el sentido de que una vez que un dispositivo WLP se integra en un módulo RF denso, Resulta en una reducción significativa en el acoplamiento parásito de EM porque la interconexión entre el dispositivo y la PCB es relativamente corta, A diferencia de la interconexión unida por cable utilizada en algunos tipos de tecnologías CSP.
Tecnología de chip de chip wlp chip
Tecnología Flip-Chip, también conocido como la conexión de chip de colapso controlado (C4), es una de varias tecnologías de ensamblaje de chips desarrolladas por IBM en la década de 1960. Aunque la tecnología de envasado basada en un enlace de cables es más flexible en términos de capacidad inductiva gratuita para la depuración de laboratorio después de que se construye el hardware, y también proporciona una buena conductividad térmica, El uso de protuberancias de soldadura en la tecnología de envasado de chips Flip hace que la conexión eléctrica entre el sustrato del paquete y el chip proporcione una reducción del tamaño relativo, latencia reducida, y mejor aislamiento en términos de sus pines de entrada y salida. Cifra 1 ilustra la estructura básica del troquel de chip en el sustrato, con una bola de soldadura en la parte superior de la columna de Cu que crece en la superficie del chip. La junta de soldadura generalmente se encapsula con un compuesto de molde de relleno para proporcionar soporte mecánico para la junta de soldadura.

Tecnología de chip de chip wlp chip
Paquete de nivel de chip WLP
Embalaje a escala de chips (CSP) es uno de los métodos de envasado más utilizados en microelectrónica y industria de semiconductores. Mientras que varios tipos de tecnologías CSP ya están disponibles para los fabricantes de microchip, Continúan surgiendo nuevos tipos para satisfacer la demanda de productos que admiten nuevas funciones y nuevos productos específicos de la aplicación. Estos requisitos de envasado pueden variar según el nivel requerido de confiabilidad., costo, características adicionales, y tamaño general. Como el nombre lo indica, El tamaño del paquete del CSP es más o menos el mismo que el tamaño del troquel de chips, que es una de sus principales ventajas. Al adoptar el proceso de fabricación de WLP, CSP se está desarrollando constantemente para lograr la relación de tamaño de morbón de paquete más pequeña posible. Como se muestra en la figura 2, la matriz de la cuadrícula de bola (BGA) El estilo de CSP en el paquete permite varias interconexiones al tiempo que simplifica el cableado de PCB, Aumento del rendimiento del ensamblaje de PCB y la reducción de los costos de fabricación.
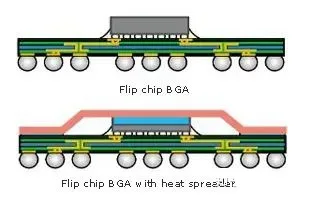
Embalaje a nivel de obleas
Otras tecnologías de encapsulación
Hay varias otras formas de embalaje IC integrado que permiten una integración perfecta en paquetes de módulos personalizados con aplicaciones. Paquete plano cuádruple (MFP) es una de las primeras tecnologías de paquetes IC de montaje en superficie,donde la estructura del paquete está compuesta de cuatro lados con cables de interconexión extendidos, Como se muestra en la figura 3(a). Los cables elevados están conectados al marco del paquete para formar un metal-a-metal (Mim) Tipo de condensador entre los cables y el chip die metal, que se puede usar como un elemento coincidente. Esta técnica es adecuada para IC del tamaño de un milímetro donde el número de pasadores periféricos en el paquete puede alcanzar más de 100 patas. Hay varios derivados de este tipo de encapsulación., dependiendo del material utilizado, como el paquete plano de cerámica cuádruple, paquete plano cuádruple delgado, paquete plano de plástico, Paquete plano de plástico) y paquete plano de metal cuádruple (MQFP). El QFN, Quad Flat No Lead, se muestra en la Fig.. 3(b) es una de varias tecnologías de envasado montadas en la superficie formadas a partir de un marco de plomo de cobre plano y un paquete de plástico utilizado como almohadilla de transferencia de calor para el radiador. La unión de cables también se puede usar para las interconexiones, y dado que las líneas de enlace no son solo conductores sino también inductores, generalmente afectan el rendimiento de los dispositivos bajo esta técnica de encapsulación, a menos que se considera parte del diseño general. Aunque el QFN es una interconexión que consta de cuatro lados, los cables sin plano no acordados (DFN) también han aparecido y forman ambos lados de los cables del plano de interconexión.
 UGPCB LOGO
UGPCB LOGO

