
BGA void Control
В мире точного производства печатных плат, Каждая деталь имеет решающее значение, Особенно, когда дело доходит до BGA (Шариковая сетка массив) упаковка. BGA Voids, или крошечные полости внутри паяных шариков, может показаться незначительным, но может скрыть основные риски, влияющие на надежность продукции. Эта статья углубится в то, как уменьшить возникновение пустот BGA с помощью тщательного управления процессом, обеспечение стабильности и безопасности электронных соединений.
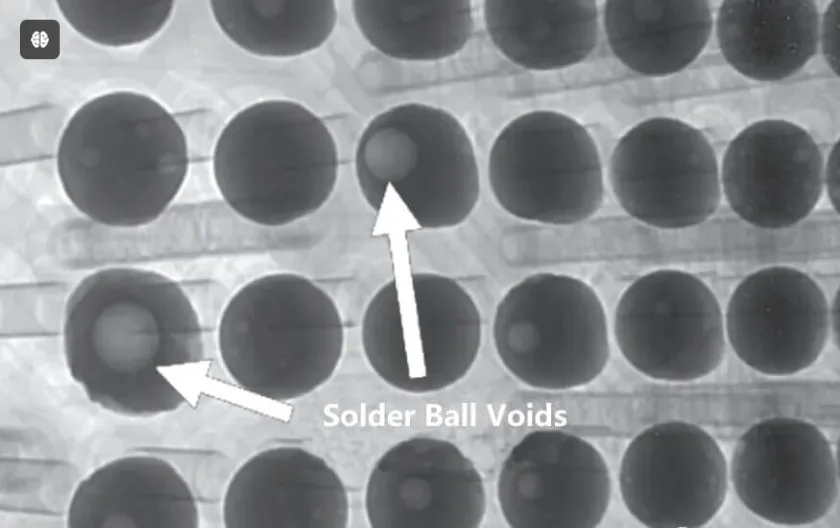
BGA void
Расположение пустот: Ключевой момент
Первый, Давайте проясним одну вещь: Не все пустоты одинаково опасны. Пустоты внутри паяных шариков, Если они не представляют прямой угрозы структурной целостности, может иметь ограниченное влияние. Однако, Когда пустоты появляются на интерфейсе между подложкой для паяла и пакетом или паяльной шар и печатной платой, Ситуация сильно отличается. Эти пустоты интерфейса действуют как потенциальные ускорители трещин; Однажды подвергаясь внешним силам, Они могут привести к трещинах припоя, сильно влияет на надежность продукции и продолжительность жизни.

Блок -схема пустого оценки
Интуитивно понять процесс оценки пустоты, Мы вводим фигуру A-1. Эта блок -схема подробно описывает каждый шаг от идентификации пустоты до принятия соответствующих действий, Служиться эффективным инструментом для обеспечения управления процессом.
Корректирующие показатели меры: Точные действия

А-1 корректирующий индекс меры для соединительных пластин, используемых с 1.5, 1.27 или 1,0 мм шаг
Для BGA с разными полями, Мы разработали подробные индикаторы корректирующей меры, Как показано в таблицах от A-1 до A-3 (Содержание которого обобщено здесь в текстовой форме). На основе стандартов МПК, Эти таблицы сочетают в себе место пустота, размер, и количество для предоставления конкретных руководящих принципов для BGA. Например, Таблица A-1 перечисляет рекомендуемые меры для различных типов и количества пустот для BGA с шагами 1,5 мм, 1.27мм, и 1,0 мм, стремление поддерживать надежность соединения.
Описание характеристики процесса: Научный контроль
Описание процесса в основе уменьшения пустот. На основе пустого размера и после предложений в блок -схеме, в сочетании с трехуровневой структурой в стандартах IPC, он рассматривает место пустота, размер, и количество, чтобы установить необходимые меры контроля. Эти меры применяются не только к непрерывной оптимизации существующих продуктов, но и к новым продуктам., Квалификация продукта и процессов, Настройка оборудования изменяется, Квалификация компонентов, и ответы на отзывы клиентов.
Проблемы и ответы на тонкую BGA

А-2 корректирующие индекс меры для соединительных пластин используется с 1.5, 1.27 или 1,0 мм шаг
По мере того, как BGA Pitch продолжает уменьшаться, Так же и область соединения, представляя более высокие требования по контролю за пустотом. Таблица A-2 специально обращается к BGA с высоты 0,8 мм, 0.65мм, и 0,5 мм, Предоставление подробных корректирующих мер. Для тонкого шага BGAS, Даже незначительные пустоты могут значительно повлиять на надежность соединения. Поэтому, более строгие меры контроля, такие как уменьшение размера пустоты, должен быть взят для компенсации за снижение зоны соединения.
Via-in-Pad Design и void-контроль

A-3 Перекорректирующий индекс меры для соединительных пластин, используемых с 1.5, 1.27 или 1,0 мм шаг
В дизайнах с меньшими видами, Микровий и конструкции Via-in-Pad становятся ключом к получению достаточного пространства маршрутизации. Однако, Это вводит новые проблемы: Как гарантировать, что эти конструкции не увеличивают риск пустот? Рисунок A-2 (Представьте себе схему, показывающую, как трещины могут распространяться из пустот) Демонстрирует, как пустоты могут повлиять на надежность приповного сустава. Чтобы избежать этого, Проекты Via-in-Pad требуют дальнейших ограничений на пустого допуска, Как показано в таблице A-3.
Стандарты управления процессом пустоты

Пустота в BGA
Размер и количество пустот являются важными показателями для оценки эффективности управления процессом. Обычное появление пустот указывает на потерю управления процессом, требует необходимых инструментов для улучшения процессов и материалов. В зависимости от размера и высоты, Мы определяем приемлемые характеристики пустот, чтобы обеспечить надежность конечного продукта.
Детали определяют успех или неудачу: Рассмотрение формы припоя шарика

Наконец, Влияние формы шарика пая на пустое управление не может быть проигнорировано. В рухну, Шар становится эллипсоидальной, а не равномерной сферой, приводя к диаметру припоя в центре шарика, который обычно больше, чем диаметр от шарика до интерфейса подключения. Это изменение формы влияет на размер и распределение пустот, следовательно, При установке стандартов, Должны быть рассмотрены различные комбинации размеров паяного мяча и подключений.
Заключение: Слияние искусства и науки
Сокращение пустот BGA через управление процессом - это слияние искусства и науки. Это требует как глубоких знаний в области электронного инженера, так и тщательного мастерства. Через точные действия и научный контроль, Мы можем эффективно уменьшить возникновение пустот, обеспечение стабильности и безопасности электронных соединений. В эту сложную и подходящую эпоху, Давайте работать вместе, чтобы исследовать больше неизвестных, Создать более надежные электронные продукты, и способствуйте человеческому технологическому прогрессу.
 ЛОГОТИП УГКПБ
ЛОГОТИП УГКПБ

